【導(dǎo)讀】根據(jù)國際半導(dǎo)體路線組織(ITRS)的定義:SiP為將多個具有不同功能的有源電子元件與可選無源器件,以及諸如MEMS或者光學(xué)器件等其他器件優(yōu)先組裝到一起,實現(xiàn)一定功能的單個標(biāo)準(zhǔn)封裝件,形成一個系統(tǒng)或者子系統(tǒng)。
超越摩爾之路——SiP簡介
根據(jù)國際半導(dǎo)體路線組織(ITRS)的定義:SiP為將多個具有不同功能的有源電子元件與可選無源器件,以及諸如MEMS或者光學(xué)器件等其他器件優(yōu)先組裝到一起,實現(xiàn)一定功能的單個標(biāo)準(zhǔn)封裝件,形成一個系統(tǒng)或者子系統(tǒng)。
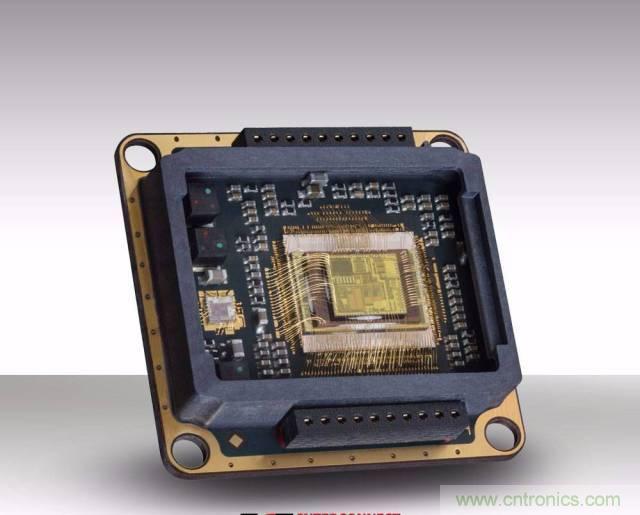
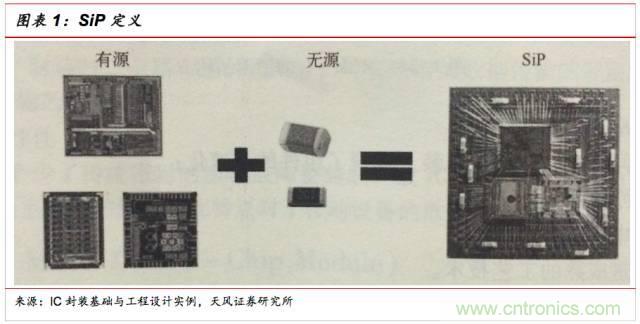
從架構(gòu)上來講,SiP是將多種功能芯片,包括處理器、存儲器等功能芯片集成在一個封裝內(nèi),從而實現(xiàn)一個基本完整的功能。與SOC(片上系統(tǒng))相對應(yīng)。不同的是系統(tǒng)級封裝是采用不同芯片進(jìn)行并排或疊加的封裝方式,而SOC則是高度集成的芯片產(chǎn)品。
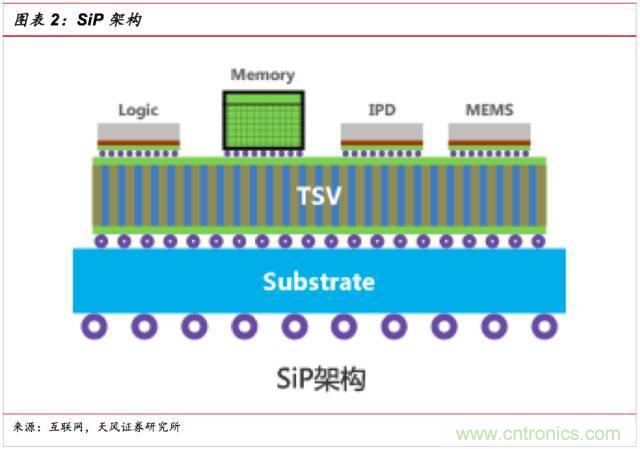
1.1. More Moore VS More than Moore——SoC與SiP之比較
SiP是超越摩爾定律下的重要實現(xiàn)路徑。眾所周知的摩爾定律發(fā)展到現(xiàn)階段,何去何從?行業(yè)內(nèi)有兩條路徑:一是繼續(xù)按照摩爾定律往下發(fā)展,走這條路徑的產(chǎn)品有CPU、內(nèi)存、邏輯器件等,這些產(chǎn)品占整個市場的50%。另外就是超越摩爾定律的More than Moore路線,芯片發(fā)展從一味追求功耗下降及性能提升方面,轉(zhuǎn)向更加務(wù)實的滿足市場的需求。這方面的產(chǎn)品包括了模擬/RF器件,無源器件、電源管理器件等,大約占到了剩下的那50%市場。

針對這兩條路徑,分別誕生了兩種產(chǎn)品:SoC與SiP。SoC是摩爾定律繼續(xù)往下走下的產(chǎn)物,而SiP則是實現(xiàn)超越摩爾定律的重要路徑。兩者都是實現(xiàn)在芯片層面上實現(xiàn)小型化和微型化系統(tǒng)的產(chǎn)物。
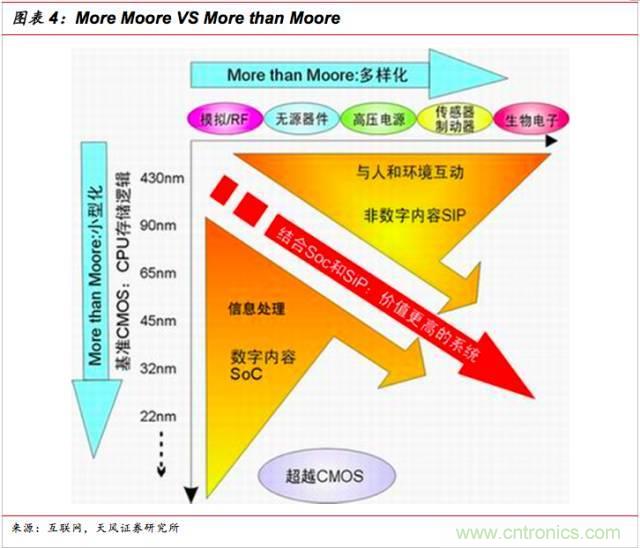
SoC與SIP是極為相似,兩者均將一個包含邏輯組件、內(nèi)存組件,甚至包含被動組件的系統(tǒng),整合在一個單位中。SoC是從設(shè)計的角度出發(fā),是將系統(tǒng)所需的組件高度集成到一塊芯片上。SiP是從封裝的立場出發(fā),對不同芯片進(jìn)行并排或疊加的封裝方式,將多個具有不同功能的有源電子元件與可選無源器件,以及諸如MEMS或者光學(xué)器件等其他器件優(yōu)先組裝到一起,實現(xiàn)一定功能的單個標(biāo)準(zhǔn)封裝件。
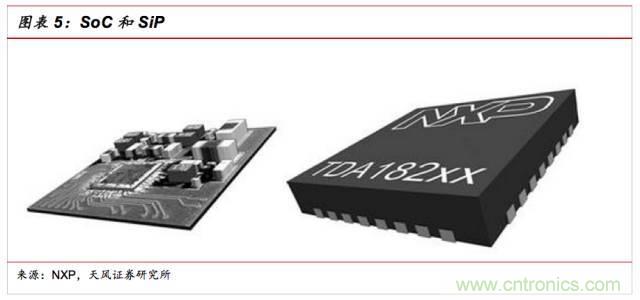
從集成度而言,一般情況下,SoC只集成AP之類的邏輯系統(tǒng),而SiP集成了AP+mobile DDR,某種程度上說SIP=SoC+DDR,隨著將來集成度越來越高,emmc也很有可能會集成到SiP中。
從封裝發(fā)展的角度來看,因電子產(chǎn)品在體積、處理速度或電性特性各方面的需求考量下,SoC曾經(jīng)被確立為未來電子產(chǎn)品設(shè)計的關(guān)鍵與發(fā)展方向。但隨著近年來SoC生產(chǎn)成本越來越高,頻頻遭遇技術(shù)障礙,造成SoC的發(fā)展面臨瓶頸,進(jìn)而使SiP的發(fā)展越來越被業(yè)界重視。

1.2. SiP——超越摩爾定律的必然選擇路徑
摩爾定律確保了芯片性能的不斷提升。眾所周知,摩爾定律是半導(dǎo)體行業(yè)發(fā)展的“圣經(jīng)”。在硅基半導(dǎo)體上,每18個月實現(xiàn)晶體管的特征尺寸縮小一半,性能提升一倍。在性能提升的同時,帶來成本的下降,這使得半導(dǎo)體廠商有足夠的動力去實現(xiàn)半導(dǎo)體特征尺寸的縮小。這其中,處理器芯片和存儲芯片是最遵從摩爾定律的兩類芯片。以Intel為例,每一代的產(chǎn)品完美地遵循摩爾定律。在芯片層面上,摩爾定律促進(jìn)了性能的不斷往前推進(jìn)。



SIP是解決系統(tǒng)桎梏的勝負(fù)手。把多個半導(dǎo)體芯片和無源器件封裝在同一個芯片內(nèi),組成一個系統(tǒng)級的芯片,而不再用PCB板來作為承載芯片連接之間的載體,可以解決因為PCB自身的先天不足帶來系統(tǒng)性能遇到瓶頸的問題。以處理器和存儲芯片舉例,因為系統(tǒng)級封裝內(nèi)部走線的密度可以遠(yuǎn)高于PCB走線密度,從而解決PCB線寬帶來的系統(tǒng)瓶頸。舉例而言,因為存儲器芯片和處理器芯片可以通過穿孔的方式連接在一起,不再受PCB線寬的限制,從而可以實現(xiàn)數(shù)據(jù)帶寬在接口帶寬上的提升。
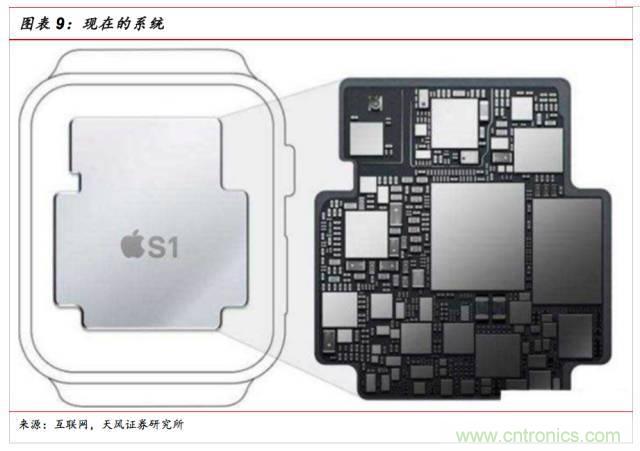
我們認(rèn)為,SiP不僅是簡單地將芯片集成在一起。SiP還具有開發(fā)周期短;功能更多;功耗更低,性能更優(yōu)良、成本價格更低,體積更小,質(zhì)量更輕等優(yōu)點,總結(jié)如下:



鍵合技術(shù)有熱壓焊、熱超聲焊等。這些技術(shù)優(yōu)點是容易形成球形(即焊球技術(shù)),并防止金線氧化。為了降低成本,也在研究用其他金屬絲,如鋁、銅、銀、鈀等來替代金絲鍵合。熱壓焊的條件是兩種金屬表面緊緊接觸,控制時間、溫度、壓力,使得兩種金屬發(fā)生連接。表面粗糙(不平整)、有氧化層形成或是有化學(xué)沾污、吸潮等都會影響到鍵合效果,降低鍵合強(qiáng)度。熱壓焊的溫度在 300℃~400℃,時間一般為 40ms(通常,加上尋找鍵合位置等程序,鍵合速度是每秒二線)。超聲焊的優(yōu)點是可避免高溫,因為它用20kHz~60kHz的超聲振動提供焊接所需的能量,所以焊接溫度可以降低一些。將熱和超聲能量同時用于鍵合,就是所謂的熱超聲焊。與熱壓焊相比,熱超聲焊最大的優(yōu)點是將鍵合溫度從 350℃降到250℃左右(也有人認(rèn)為可以用100℃~150℃的條件),這可以大大降低在鋁焊盤上形成 Au-Al 金屬間化合物的可能性,延長器件壽命,同時降低了電路參數(shù)的漂移。在引線鍵合方面的改進(jìn)主要是因為需要越來越薄的封裝,有些超薄封裝的厚度僅有0.4mm 左右。所以引線環(huán)(loop)從一般的200 μ m~300 μ m減小到100μm~125μm,這樣引線張力就很大,繃得很緊。另外,在基片上的引線焊盤外圍通常有兩條環(huán)狀電源 / 地線,鍵合時要防止金線與其短路,其最小間隙必須>625 μ m,要求鍵合引線必須具有高的線性度和良好的弧形。
等離子清洗
清洗的重要作用之一是提高膜的附著力,如在Si 襯底上沉積 Au 膜,經(jīng) Ar 等離子體處理掉表面的碳?xì)浠衔锖推渌廴疚?,明顯改善了 Au 的附著力。等離子體處理后的基體表面,會留下一層含氟化物的灰色物質(zhì),可用溶液去掉。同時清洗也有利于改善表面黏著性和潤濕性。
液態(tài)密封劑灌封
將已貼裝好芯片并完成引線鍵合的框架帶置于模具中,將塑封料的預(yù)成型塊在預(yù)熱爐中加熱(預(yù)熱溫度在 90℃~95℃之間),然后放進(jìn)轉(zhuǎn)移成型機(jī)的轉(zhuǎn)移罐中。在轉(zhuǎn)移成型活塞的壓力之下,塑封料被擠壓到澆道中,并經(jīng)過澆口注入模腔(在整個過程中,模具溫度保持在 170℃~175℃左右)。塑封料在模具中快速固化,經(jīng)過一段時間的保壓,使得模塊達(dá)到一定的硬度,然后用頂桿頂出模塊,成型過程就完成了。對于大多數(shù)塑封料來說,在模具中保壓幾分鐘后,模塊的硬度足可以達(dá)到允許頂出的程度,但是聚合物的固化(聚合)并未全部完成。由于材料的聚合度(固化程度)強(qiáng)烈影響材料的玻璃化轉(zhuǎn)變溫度及熱應(yīng)力,所以促使材料全部固化以達(dá)到一個穩(wěn)定的狀態(tài),對于提高器件可靠性是十分重要的,后固化就是為了提高塑封料的聚合度而必需的工藝步驟,一般后固化條件為 170℃~175℃,2h~4h。
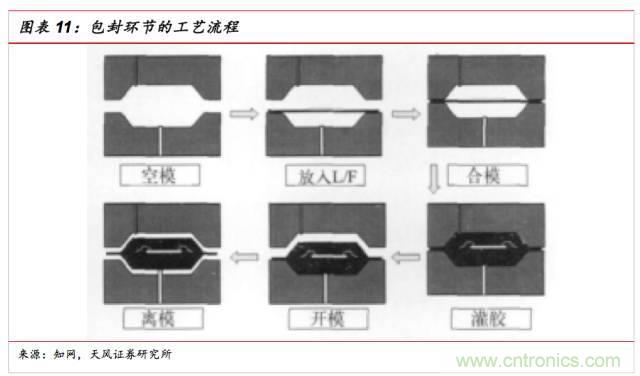
液態(tài)密封劑灌封
目前業(yè)內(nèi)采用的植球方法有兩種:“錫膏”+“錫球”和“助焊膏”+ “錫球”。“錫膏”+“錫球”植球方法是業(yè)界公認(rèn)的最好標(biāo)準(zhǔn)的植球法,用這種方法植出的球焊接性好、光澤好,熔錫過程不會出現(xiàn)焊球偏置現(xiàn)象,較易控制,具體做法就是先把錫膏印刷到 BGA 的焊盤上,再用植球機(jī)或絲網(wǎng)印刷在上面加上一定大小的錫球,這時錫膏起的作用就是粘住錫球,并在加溫的時候讓錫球的接觸面更大,使錫球的受熱更快更全面,使錫球熔錫后與焊盤焊接性更好并減少虛焊的可能。
表面打標(biāo)
打標(biāo)就是在封裝模塊的頂表面印上去不掉的、字跡清楚的字母和標(biāo)識,包括制造商的信息、國家、器件代碼等,主要是為了識別并可跟蹤。打碼的方法有多種,其中最常用的是印碼方法,而它又包括油墨印碼和激光印碼二種。
分離
為了提高生產(chǎn)效率和節(jié)約材料,大多數(shù) SIP 的組裝工作都是以陣列組合的方式進(jìn)行,在完成模塑與測試工序以后進(jìn)行劃分,分割成為單個的器件。劃分分割可以采用鋸開或者沖壓工藝,鋸開工藝靈活性比較強(qiáng),也不需要多少專用工具,沖壓工藝則生產(chǎn)效率比較高、成本較低,但是需要使用專門的工具。
2.2.倒裝焊工藝
和引線鍵合工藝相比較倒裝焊工藝具有以下幾個優(yōu)點:
(1)倒裝焊技術(shù)克服了引線鍵合焊盤中心距極限的問題;
(2)在芯片的電源 /地線分布設(shè)計上給電子設(shè)計師提供了更多的便利;
(3)通過縮短互聯(lián)長度,減小 RC 延遲,為高頻率、大功率器件提供更完善的信號;

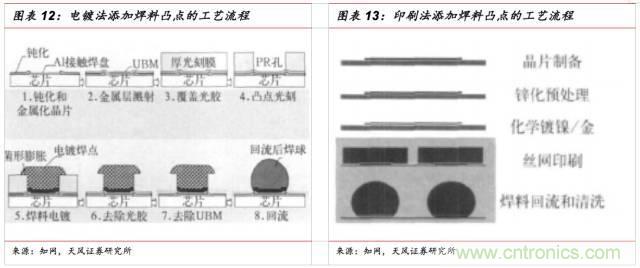
倒裝鍵合、下填充
在整個芯片鍵合表面按柵陣形狀布置好焊料凸點后,芯片以倒扣方式安裝在封裝基板上,通過凸點與基板上的焊盤實現(xiàn)電氣連接,取代了WB和TAB 在周邊布置端子的連接方式。倒裝鍵合完畢后,在芯片與基板間用環(huán)氧樹脂進(jìn)行填充,可以減少施加在凸點上的熱應(yīng)力和機(jī)械應(yīng)力,比不進(jìn)行填充的可靠性提高了1到2個數(shù)量級。
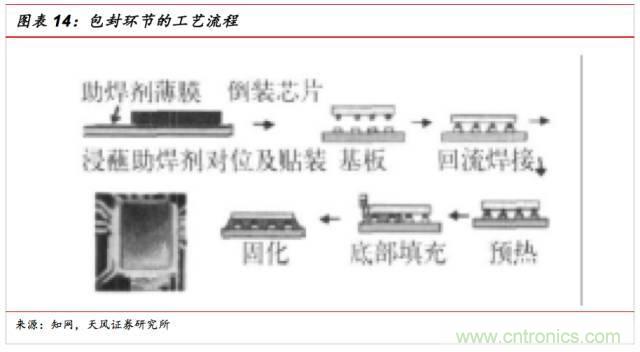
SiP——為應(yīng)用而生
3.1.主要應(yīng)用領(lǐng)域
SiP的應(yīng)用非常廣泛,主要包括:無線通訊、汽車電子、醫(yī)療電子、計算機(jī)、軍用電子等。
應(yīng)用最為廣泛的無線通訊領(lǐng)域。SiP在無線通信領(lǐng)域的應(yīng)用最早,也是應(yīng)用最為廣泛的領(lǐng)域。在無線通訊領(lǐng)域,對于功能傳輸效率、噪聲、體積、重量以及成本等多方面要求越來越高,迫使無線通訊向低成本、便攜式、多功能和高性能等方向發(fā)展。SiP是理想的解決方案,綜合了現(xiàn)有的芯核資源和半導(dǎo)體生產(chǎn)工藝的優(yōu)勢,降低成本,縮短上市時間,同時克服了SOC中諸如工藝兼容、信號混合、噪聲干擾、電磁干擾等難度。手機(jī)中的射頻功放,集成了頻功放、功率控制及收發(fā)轉(zhuǎn)換開關(guān)等功能,完整的在SiP中得到了解決。
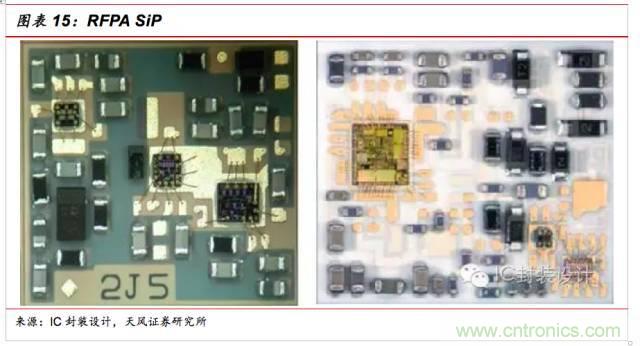
汽車電子是SiP的重要應(yīng)用場景。汽車電子里的SiP應(yīng)用正在逐漸增加。以發(fā)動機(jī)控制單元(ECU)舉例,ECU由微處理器(CPU)、存儲器(ROM、RAM)、輸入/輸出接口(I/O)、模數(shù)轉(zhuǎn)換器(A/D)以及整形、驅(qū)動等大規(guī)模集成電路組成。各類型的芯片之間工藝不同,目前較多采用SiP的方式將芯片整合在一起成為完整的控制系統(tǒng)。另外,汽車防抱死系統(tǒng)(ABS)、燃油噴射控制系統(tǒng)、安全氣囊電子系統(tǒng)、方向盤控制系統(tǒng)、輪胎低氣壓報警系統(tǒng)等各個單元,采用SiP的形式也在不斷增多。此外,SIP技術(shù)在快速增長的車載辦公系統(tǒng)和娛樂系統(tǒng)中也獲得了成功的應(yīng)用。
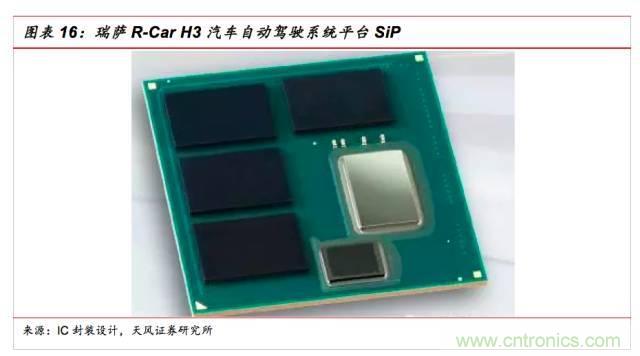
醫(yī)療電子需要可靠性和小尺寸相結(jié)合,同時兼具功能性和壽命。在該領(lǐng)域的典型應(yīng)用為可植入式電子醫(yī)療器件,比如膠囊式內(nèi)窺鏡。內(nèi)窺鏡由光學(xué)鏡頭、圖像處理芯片、射頻信號發(fā)射器、天線、電池等組成。其中圖像處理芯片屬于數(shù)字芯片、射頻信號發(fā)射器則為模擬芯片、天線則為無源器件。將這些器件集中封裝在一個SiP之內(nèi),可以完美地解決性能和小型化的要求。

SiP在計算機(jī)領(lǐng)域的應(yīng)用主要來自于將處理器和存儲器集成在一起。以GPU舉例,通常包括圖形計算芯片和SDRAM。而兩者的封裝方式并不相同。圖形計算方面都采用標(biāo)準(zhǔn)的塑封焊球陣列多芯片組件方式封裝,而這種方式對于SDRAM并不適合。因此需要將兩種類型的芯片分別封裝之后,再以SiP的形式封裝在一起。
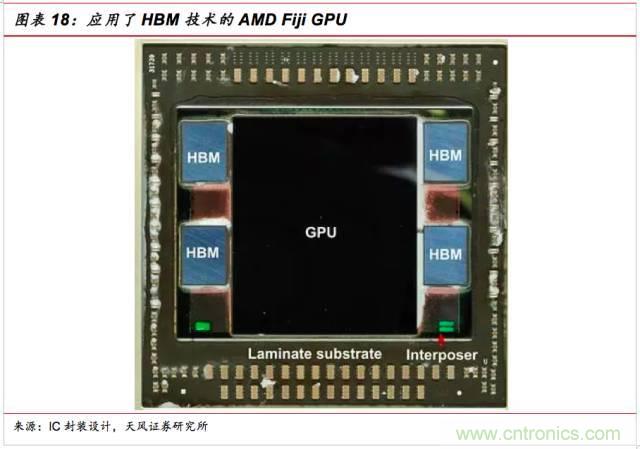
SiP在其他消費類電子中也有很多應(yīng)用。這其中包括了ISP(圖像處理芯片)、藍(lán)牙芯片等。ISP是數(shù)碼相機(jī)、掃描儀、攝像頭、玩具等電子產(chǎn)品的核心器件,其通過光電轉(zhuǎn)換,將光學(xué)信號轉(zhuǎn)換成數(shù)字信號,然后實現(xiàn)圖像的處理、顯示和存儲。圖像傳感器包括一系列不同類型的元器件,如CCD、COMS圖像傳感器、接觸圖像傳感器、電荷載入器件、光學(xué)二極管陣列、非晶硅傳感器等,SiP技術(shù)無疑是一種理想的封裝技術(shù)解決方案。
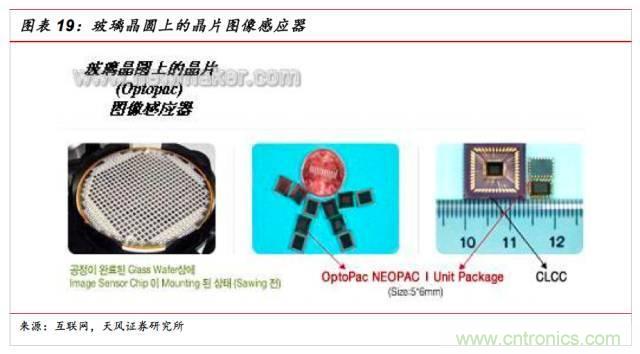
藍(lán)牙系統(tǒng)一般由無線部分、鏈路控制部分、鏈路管理支持部分和主終端接口組成,SiP技術(shù)可以使藍(lán)牙做得越來越小迎合了市場的需求,從而大力推動了藍(lán)牙技術(shù)的應(yīng)用。SiP完成了在一個超小型封裝內(nèi)集成了藍(lán)牙無線技術(shù)功能所需的全部原件(無線電、基帶處理器、ROM、濾波器及其他分立元件)。
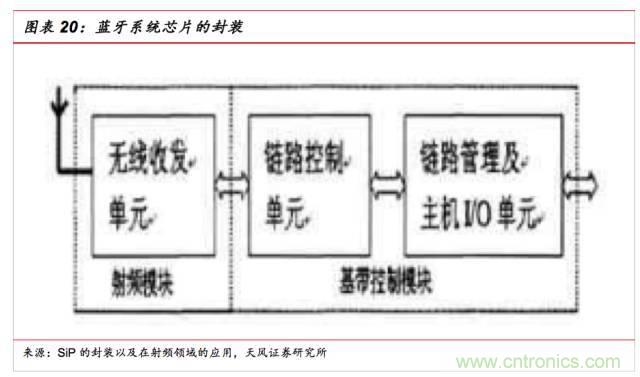


從蘋果產(chǎn)品看SiP應(yīng)用。蘋果是堅定看好SiP應(yīng)用的公司,蘋果在之前Apple Watch上就已經(jīng)使用了SiP封裝。

除了手表以外,蘋果手機(jī)中使用SiP的顆數(shù)也在逐漸增多。列舉有:觸控芯片,指紋識別芯片,RFPA等。
觸控芯片。在Iphone6中,觸控芯片有兩顆,分別由Broadcom和TI提供,而在6S中,將這兩顆封在了同一個package內(nèi),實現(xiàn)了SiP的封裝。而未來會進(jìn)一步將TDDI整個都封裝在一起。iPhone6s中展示了新一代的3D Touch技術(shù)。觸控感應(yīng)檢測可以穿透絕緣材料外殼,通過檢測人體手指帶來的電壓變化,判斷出人體手指的觸摸動作,從而實現(xiàn)不同的功能。而觸控芯片就是要采集接觸點的電壓值,將這些電極電壓信號經(jīng)過處理轉(zhuǎn)換成坐標(biāo)信號,并根據(jù)坐標(biāo)信號控制手機(jī)做出相應(yīng)功能的反應(yīng),從而實現(xiàn)其控制功能。3D Touch的出現(xiàn),對觸控模組的處理能力和性能提出了更高的要求,其復(fù)雜結(jié)構(gòu)要求觸控芯片采用SiP組裝,觸覺反饋功能加強(qiáng)其操作友好性。
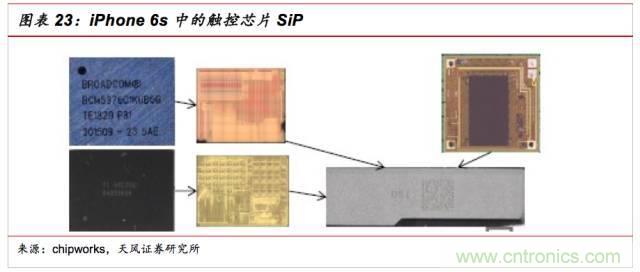
指紋識別同樣采用了SiP封裝。將傳感器和控制芯片封裝在一起,從iPhone 5開始,就采取了相類似的技術(shù)。
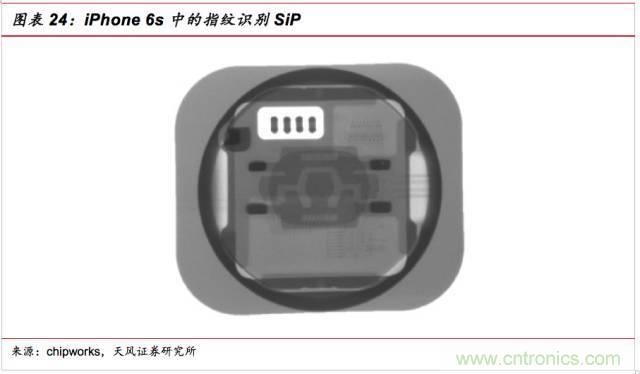
RFPA模塊。手機(jī)中的RFPA是最常用SiP形式的。iPhone 6S也同樣不例外,在iPhone 6S中,有多顆RFPA芯片,都是采用了SiP。
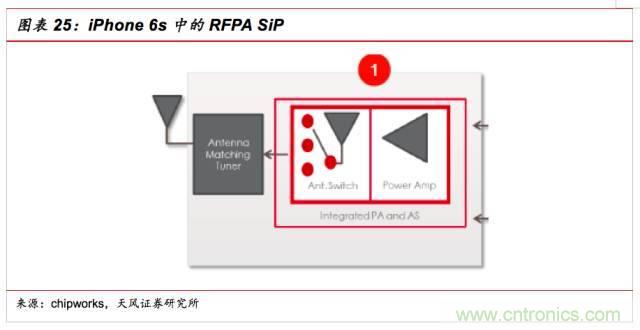
按照蘋果的習(xí)慣,所有應(yīng)用成熟的技術(shù)會傳給下一代,我們判斷,即將問世的蘋果iPhone7會更多地采取SiP技術(shù),而未來的iPhone7s、iPhone8會更全面,更多程度的利用SiP技術(shù),來實現(xiàn)內(nèi)部空間的壓縮。
快速增長的SiP市場
4.1.市場規(guī)模&滲透率迅速提升
2013-2016SiP市場CAGR=15%。2014年全球SiP產(chǎn)值約為48.43億美元,較2013年成長12.4%左右;2015年在智慧型手機(jī)仍持續(xù)成長,以及Apple Watch等穿戴式產(chǎn)品問世下,全球SiP產(chǎn)值估計達(dá)到55.33億美元,較2014年成長14.3%。
2016年,雖然智慧型手機(jī)可能逐步邁入成熟期階段,難有大幅成長的表現(xiàn),但SiP在應(yīng)用越趨普及的趨勢下,仍可呈現(xiàn)成長趨勢,因此,預(yù)估2016年全球SiP產(chǎn)值仍將可較2015年成長17.4%,來到64.94億美元。

市場滲透率將迅速提升。我們預(yù)計,SiP在智能手機(jī)中的滲透率將從2016年的10%迅速提升到2018年的40%。在輕薄化趨勢已經(jīng)確定的情況下,能完美實現(xiàn)輕薄化要求的SiP理應(yīng)會得到更多的應(yīng)用。不止是蘋果,我們預(yù)計國內(nèi)智能手機(jī)廠商也會迅速跟進(jìn)。此外,滲透率提升不單是采用SiP的智能手機(jī)會增多,在智能手機(jī)中使用的SiP的顆數(shù)也會增加。兩個效應(yīng)疊加驅(qū)使SiP的增量市場迅速擴(kuò)大。
我們測算SiP在智能手機(jī)市場未來三年內(nèi)的市場規(guī)模。假設(shè)SiP的單價每年降價10%,智能手機(jī)出貨量年增3%??梢钥吹?,SiP在智能手機(jī)中的新增市場規(guī)模CAGR=192%,非??捎^。

4.2.從制造到封測——逐漸融合的SiP產(chǎn)業(yè)鏈
從產(chǎn)業(yè)鏈的變革、產(chǎn)業(yè)格局的變化來看,今后電子產(chǎn)業(yè)鏈將不再只是傳統(tǒng)的垂直式鏈條:終端設(shè)備廠商——IC設(shè)計公司——封測廠商、Foundry廠、IP設(shè)計公司,產(chǎn)品的設(shè)計將同時調(diào)動封裝廠商、基板廠商、材料廠、IC設(shè)計公司、系統(tǒng)廠商、Foundry廠、器件廠商(如TDK、村田)、存儲大廠(如三星)等彼此交叉協(xié)作,共同實現(xiàn)產(chǎn)業(yè)升級。未來系統(tǒng)將帶動封裝業(yè)進(jìn)一步發(fā)展,反之高端封裝也將推動系統(tǒng)終端繁榮。未來系統(tǒng)廠商與封裝廠的直接對接將會越來越多,而IC設(shè)計公司則將可能向IP設(shè)計或者直接出售晶圓兩個方向去發(fā)展。
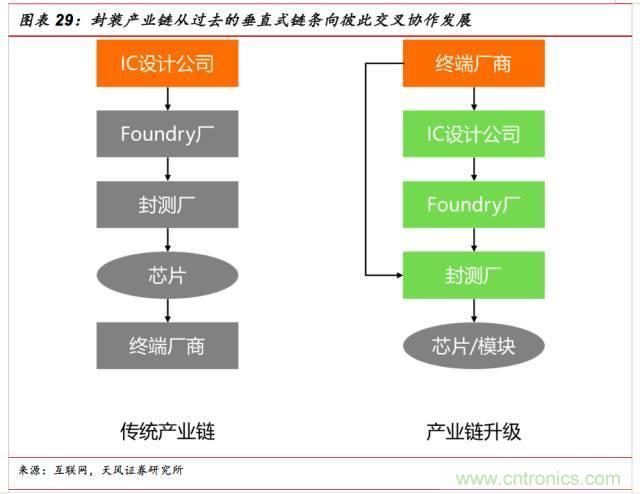
近年來,部分晶圓代工廠也在客戶一次購足的服務(wù)需求下(Turnkey Service),開始擴(kuò)展業(yè)務(wù)至下游封測端,以發(fā)展SiP等先進(jìn)封裝技術(shù)來打造一條龍服務(wù)模式,滿足上游IC設(shè)計廠或系統(tǒng)廠。然而,晶圓代工廠發(fā)展SiP等先進(jìn)封裝技術(shù),與現(xiàn)有封測廠商間將形成微妙的競合關(guān)系。首先,晶圓代工廠基于晶圓制程優(yōu)勢,擁有發(fā)展晶圓級封裝技術(shù)的基本條件,跨入門檻并不甚高。因此,晶圓代工廠可依產(chǎn)品應(yīng)用趨勢與上游客戶需求,在完成晶圓代工相關(guān)制程后,持續(xù)朝晶圓級封裝等后段領(lǐng)域邁進(jìn),以完成客戶整體需求目標(biāo)。這對現(xiàn)有封測廠商來說,可能形成一定程度的競爭。
由于封測廠幾乎難以向上游跨足晶圓代工領(lǐng)域,而晶圓代工廠卻能基于制程技術(shù)優(yōu)勢跨足下游封測代工,尤其是在高階SiP領(lǐng)域方面;因此,晶圓代工廠跨入SiP封裝業(yè)務(wù),將與封測廠從單純上下游合作關(guān)系,轉(zhuǎn)向微妙的競合關(guān)系。
封測廠一方面可朝差異化發(fā)展以區(qū)隔市場,另一方面也可選擇與晶圓代工廠進(jìn)行技術(shù)合作,或是以技術(shù)授權(quán)等方式,搭配封測廠龐大的產(chǎn)能基礎(chǔ)進(jìn)行接單量產(chǎn),共同擴(kuò)大市場。此外,晶圓代工廠所發(fā)展的高階異質(zhì)封裝,其部份制程步驟仍須專業(yè)封測廠以現(xiàn)有技術(shù)協(xié)助完成,因此雙方仍有合作立基點。
4.3.SiP行業(yè)標(biāo)的
日月光+環(huán)旭電子:
全球主要封測大廠中,日月光早在2010年便購并電子代工服務(wù)廠(EMS)--環(huán)旭電子,以本身封裝技術(shù)搭配環(huán)電在模組設(shè)計與系統(tǒng)整合實力,發(fā)展SiP技術(shù)。使得日月光在SiP技術(shù)領(lǐng)域維持領(lǐng)先地位,并能夠陸續(xù)獲得手機(jī)大廠蘋果的訂單,如Wi-Fi、處理器、指紋辨識、壓力觸控、MEMS等模組,為日月光帶來后續(xù)成長動力。
此外,日月光也與DRAM制造大廠華亞科策略聯(lián)盟,共同發(fā)展SiP范疇的TSV 2.5D IC技術(shù);由華亞科提供日月光硅中介層(Silicon Interposer)的硅晶圓生產(chǎn)制造,結(jié)合日月光在高階封測的制程能力,擴(kuò)大日月光現(xiàn)有封裝產(chǎn)品線。
不僅如此,日月光也與日本基板廠商TDK合作,成立子公司日月陽,生產(chǎn)集成電路內(nèi)埋式基板,可將更多的感測器與射頻元件等晶片整合在尺寸更小的基板上,讓SiP電源耗能降低,體積更小,以適應(yīng)可穿戴裝置與物聯(lián)網(wǎng)的需求。
日月光今年主要成長動力將來自于SiP,1H2016 SiP營收已近20億美元,預(yù)期未來5-10年,SiP會是公司持續(xù)增長的動力。日月光旗下的環(huán)旭電子繼拿下A公司的穿戴式手表SiP大單之后,也再拿下第二家美系大廠智慧手表SiP訂單,預(yù)定明年出貨。

長電+星科金朋:
長電是國內(nèi)少數(shù)可以達(dá)到國際技術(shù)水平的半導(dǎo)體封測企業(yè),2015年攜手中芯國際及國家大基金,以7.8億美元收購新加坡星科金朋,全球排名由第六晉級至第四。公司在SIP封裝方面具有一定的技術(shù)優(yōu)勢,已成功開發(fā)了RF-SIM;Micro SD;USB;FC-BGA;LGA module等一系列產(chǎn)品。
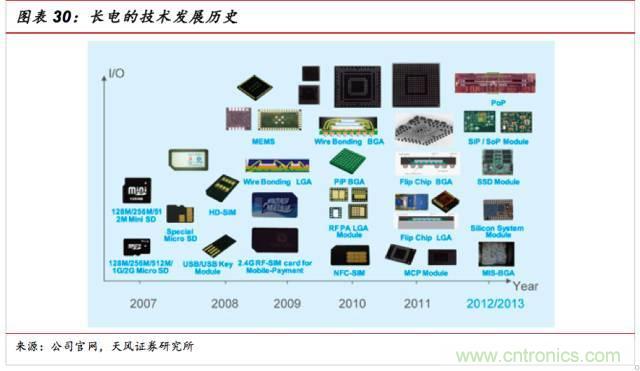
原本位居全球第四大封測廠的星科金朋也在韓國廠區(qū)積極開發(fā)SiP技術(shù),但因整體營運狀況不如前三大廠,因此難以投入大額資本以擴(kuò)充SiP規(guī)模。不過,隨著江蘇長電并購星科金朋而帶來資金,將能夠結(jié)合原本星科金朋的技術(shù),將SiP繼續(xù)做大。長電科技將投入4.75億美金擴(kuò)充SiP項目,目前星科金朋韓國廠已經(jīng)正式量產(chǎn),產(chǎn)能利用率95%以上,主要為A客戶供貨。我們預(yù)計,未來隨著A客戶BOM中SiP量的增多,將給公司帶來極大彈性。
推薦邏輯
SiP代表了行業(yè)發(fā)展方向。芯片發(fā)展從一味追求功耗下降及性能提升(摩爾定律),轉(zhuǎn)向更加務(wù)實的滿足市場的需求(超越摩爾定律),SiP是實現(xiàn)的重要路徑。SiP從終端電子產(chǎn)品角度出發(fā),不是一味關(guān)注芯片本身的性能/功耗,而是實現(xiàn)整個終端電子產(chǎn)品的輕薄短小、多功能、低功耗,在行動裝置與穿戴裝置等輕巧型產(chǎn)品興起后,SiP需求日益顯現(xiàn)。
SiP在智能手機(jī)里的滲透率在迅速提升。SiP市場2013-2015的CAGR達(dá)到16%,高于智能手機(jī)市場7%的CAGR。隨著智能手機(jī)的輕薄化趨勢確定,SiP的滲透率將迅速提升,預(yù)計將從現(xiàn)在的10%到2018年的40%。我們強(qiáng)調(diào),要重視智能手機(jī)里的任何一個新變化,在達(dá)到40%的滲透率之前,都是值得關(guān)注的快速成長期。
從行業(yè)配置角度看,SiP尚未完全Price in,有成長空間。安靠和日月光在Q2財報中,不約而同給出環(huán)比增長的原因之一來自于SiP封裝的放量。同時,蘋果確定在新機(jī)型中使用多顆SiP,而國內(nèi)廠商尚未開始跟上。我們測算2018年潛在的SiP增量空間為96億美元,從行業(yè)配置角度看,目前SiP的成長尚未被市場充分認(rèn)識,有足夠的上升空間。我們認(rèn)為,國內(nèi)的上市公司中,長電科技(收購的星科金朋為A客戶提供SiP產(chǎn)品)、環(huán)旭電子(Apple watch SiP供應(yīng)商)將深度受益于SiP行業(yè)的發(fā)展,推薦關(guān)注。
推薦閱讀:






