【導(dǎo)讀】從低密度的后通孔TSV硅3D集成技術(shù),到高密度的引線混合鍵合或3D VSLI CoolCubeTM解決方案,研究人員發(fā)現(xiàn)許多開發(fā)新產(chǎn)品的機(jī)會。本文概述了當(dāng)前新興的硅3D集成技術(shù),討論了圖像傳感器、光子器件、MEMS、Wide I/O存儲器和布局先進(jìn)邏輯電路的硅中介層,圍繞3D平臺性能評估,重點(diǎn)介紹硅3D封裝的主要挑戰(zhàn)和技術(shù)發(fā)展。
硅的3D應(yīng)用機(jī)會
從最初為圖像傳感器設(shè)計的硅2.5D集成技術(shù),到復(fù)雜的高密度的高性能3D系統(tǒng),硅3D集成是在同一芯片上集成所有功能的系統(tǒng)芯片(SoC)之外的另一種支持各種類型的應(yīng)用的解決方案,可用于創(chuàng)建性價比更高的系統(tǒng)。硅3D集成技術(shù)的主要優(yōu)勢:縮短互連線長度,降低R.C積,讓先進(jìn)系統(tǒng)芯片(SoC)能夠垂直劃分功能,進(jìn)一步降低系統(tǒng)尺寸和外形因數(shù)。
在首批出現(xiàn)的3D產(chǎn)品中,業(yè)界認(rèn)為存儲器層疊方案可以提高DRAM/邏輯控制器的容量/帶寬,適用于高性能計算系統(tǒng)、圖形處理器、服務(wù)器和微型服務(wù)器(圖1)。
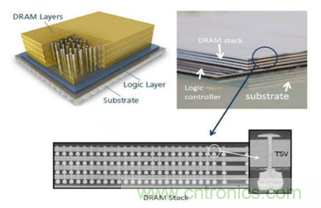
圖1:與邏輯控制器相連的DRAM混合存儲器層疊模塊(HMC)(來源:美光)。
美光的混合存儲器模塊(HMC)和海力士的寬帶存儲器(HBM)開始進(jìn)入量產(chǎn)階段,這兩個解決方案都連接硅中介層,面向高性能計算(HPC)應(yīng)用。
Xilinx于2012年提出在硅中介層制造現(xiàn)場可編程門陣列(FPGA)的概念,該技術(shù)最初采用CoWoS集成工藝,引起供應(yīng)鏈巨變,后來改用兩個28nm FPGA和兩個65nm混合信號芯片堆疊在65nm中介層上。
服務(wù)器對高帶寬和低功耗的進(jìn)一步需求催生了將CMOS/BiCMOS和光子功能分開的每個通道傳輸速率高達(dá)25Gb/s的硅光子器件平臺(圖2),以及產(chǎn)生了硅光中介層集成技術(shù)。
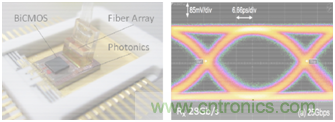
圖2左圖:一個采用3D層疊技術(shù)在光子器件上安裝BiCMOS器件的光學(xué)封裝測試芯片;右圖:該芯片在RX 25/28Gbps時的電眼測量圖
研究人員認(rèn)為在邏輯層上堆疊存儲層可以大幅降低存儲器與處理器之間的接口功耗。堆疊在邏輯層上的Wide I/O DRAM(圖3)的能效是LPDDR解決方案的四倍,并且在未來幾年內(nèi)傳輸速率將達(dá)到50GB/s。
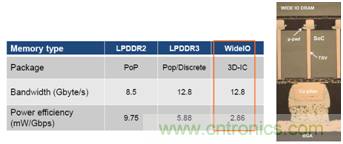
圖3:置于65nm邏輯層上的Wide IO存儲器,頂層/底層具有1250個TSV互連線,1000個倒裝片銅柱(底部/BGA)。
為了給高性能計算或電信應(yīng)用提供高帶寬性能,研究人員設(shè)計了一個基于異步3D Network-On-Chip架構(gòu)的先進(jìn)邏輯層疊方案,采用3D封裝方法將兩顆相同的邏輯裸片正反面層疊,證明了可擴(kuò)展的同構(gòu)3D層疊方法的技術(shù)優(yōu)勢。該3D集成方案的邏輯芯片采用CMOS 65nm制造工藝,使用寬高比為1:8的TSV Middle通孔和40μm節(jié)距的銅柱連接芯片(圖4)。
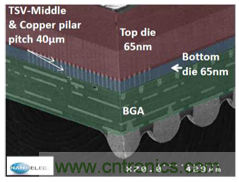
圖4:采用邏輯芯片層疊方法的異步Network-on-Chip 3D架構(gòu)
在2.5D TSV被引入CMOS圖像傳感器(圖5)后,3D集成技術(shù)從2013年開始進(jìn)入智能手機(jī)和平板電腦中,目前市場上存在多個不同的相互競爭的層疊技術(shù),數(shù)字處理層可以布局在硅襯底上,而不是像素陣列電路上,通過功能劃分和工序優(yōu)化,圖像傳感器尺寸變得更加緊湊(圖6)。
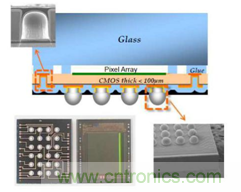
圖5:晶圓級攝像頭2.5D后通孔方法。
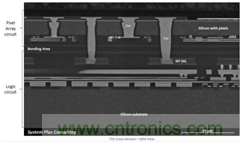
圖6:索尼圖像傳感器采用直接鍵合+TSV的晶圓級層疊解決方案(來源:System Plus Consulting)。
對于MEMS,微縮化是除成本和性能之外的另一個差異化要素。2007年以來,技術(shù)發(fā)展趨勢是開發(fā)3D異構(gòu)MEMS功能,包括通過TSV連接IC(圖7)。
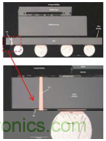
圖7:博世采用TSV 3D技術(shù)在ASIC中集成3軸加速度計(來源:Yole Developpement)。
3D技術(shù)挑戰(zhàn)
3D集成被廣泛應(yīng)用證明,TSV等先進(jìn)技術(shù)節(jié)點(diǎn)的基本模塊技術(shù)已經(jīng)成熟(圖8)?,F(xiàn)在,研發(fā)重點(diǎn)轉(zhuǎn)移到由市場需求驅(qū)動的新挑戰(zhàn)上:封裝應(yīng)變管理;通過改進(jìn)散熱效率提高系統(tǒng)性能;提高芯片間的互連密度。
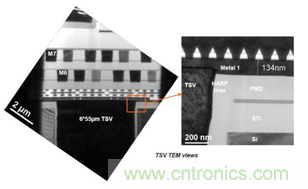
圖8:6x55µm 28FDSOI Via Middle集成TEM視圖,對測試載具良率沒有影響,通過了TDDB、EMG和TC測試
對于較大的硅中介層來說,熱機(jī)械應(yīng)變是一個需要考慮的難題,需要解決硅光子變化以及HBM/CPU集成封裝問題,疊層之間的熱膨脹系數(shù)(CTE)不匹配將會致使裸片翹曲。根據(jù)裸片級曲率對溫度的敏感性,研究人員開發(fā)出一種應(yīng)變監(jiān)測和翹曲補(bǔ)償策略,通過綜合使用陰影莫爾干涉儀(圖9)、現(xiàn)場應(yīng)力傳感器和有限元建模(FEM)方法,創(chuàng)建了介電層特性模型。(圖10)
對于MEMS,微縮化是除成本和性能之外的另一個差異化要素。2007年以來,技術(shù)發(fā)展趨勢是開發(fā)3D異構(gòu)MEMS功能,包括通過TSV連接IC(圖7)。

圖9:使用ShadowMoiré干涉儀在室溫下測量80µm硅中介層的裸片級翹曲,測量結(jié)果有一個球面非線性翹曲。
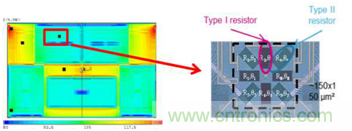
圖10:中介層機(jī)械應(yīng)力場模擬(左圖)和8片負(fù)應(yīng)變傳感器放置方式(右圖)。
研究人員利用X射線衍射技術(shù)對TSV集成引起的局部應(yīng)變進(jìn)行了表征實(shí)驗(yàn)(圖11)。同步輻射源納米級聚焦X射線衍射測量圖高亮顯示了TSV周圍應(yīng)變的2D平面分布情況,并證明應(yīng)變分布與3D FEM模擬相關(guān)。
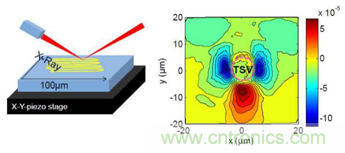
圖11:使用納米聚焦X射線束衍射方法測量的TSV周圍應(yīng)變2D平面空間應(yīng)變分布。稀化樣品是在室溫和原位退火過程中完成測量。
熱管理是業(yè)界關(guān)注的影響3D性能的一個主要問題。精確的FEM模型和在TSV 3D電路上校準(zhǔn)的緊湊型熱模型有益于設(shè)計流程改進(jìn),研究人員做過高導(dǎo)熱率散熱器材料的評測,這種材料可以提高封裝的散熱性能,耐受更大的耗散功耗,可以顯著降低潛在的局部熱點(diǎn)效應(yīng)(圖12),高性能冷卻技術(shù)被證明具有嵌入式微流體特性(圖13)。

圖12:3D電路被動散熱器評估:頂層裸片使用銅散熱器與使用熱解石墨薄板(PGS)散熱器的溫度原位測量對比(300mW熱點(diǎn))。
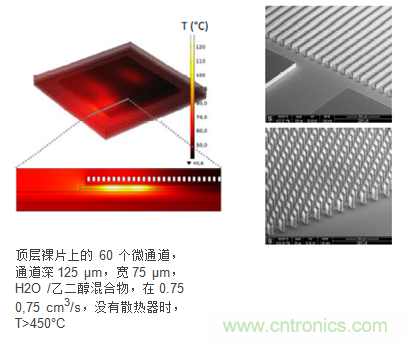
圖13左圖)在一個熱點(diǎn)密集且密閉Wioming 3D電路上的微流體冷卻技術(shù)(2000W/cm²)。右圖)在Si中蝕刻的微通道和鰭引腳的SEM圖像
互連密度提高:混合引線鍵合工藝是一個前景很好的微凸點(diǎn)技術(shù)的替代方法,或者可以替代裸片互連使用的TSV直接氧化物鍵合方法(圖14)。
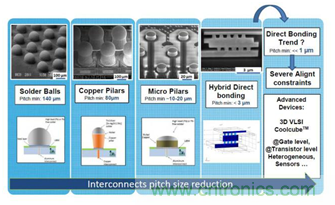
圖14:互連線間距隨著新技術(shù)解決方案和機(jī)會的出現(xiàn)而發(fā)展變化。
混合鍵合工藝允許在后工序進(jìn)行低節(jié)距的面對面的層疊,但也給集成和設(shè)計優(yōu)化帶來新挑戰(zhàn)。
CEA-Leti發(fā)布了一個集成背面照明(BSI)與控制邏輯單元的晶圓級混合鍵合封裝,證明低節(jié)距(5µm至24µm)焊盤對準(zhǔn)精度在400nm以下,并使用了2x6金屬層0.13µm雙大馬士革鑲嵌工藝(圖15)。

圖15:混合鍵合封裝的SEM圖像(俯視圖和3D視圖),包括BSI成像器結(jié)構(gòu)+邏輯的所有金屬層。
為避開非鍵合區(qū)域,必須優(yōu)化焊盤設(shè)計和表面拋光工序。套刻精度優(yōu)于250nm的高性能對準(zhǔn)系統(tǒng)能夠?qū)崿F(xiàn)最低7µm的高密度節(jié)距(圖16)。

研究人員做了鍵合界面完整性表征實(shí)驗(yàn),在附加的熱應(yīng)變實(shí)驗(yàn)后進(jìn)行EDX分析,未在氧化層發(fā)現(xiàn)銅擴(kuò)散現(xiàn)象(圖17)。
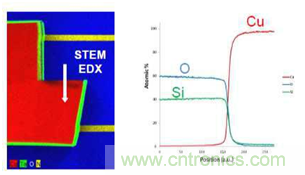
圖17:EDX混合鍵合界面表征,實(shí)驗(yàn)顯示無銅通過界面擴(kuò)散(在焊盤失準(zhǔn)情況下)。
一份有關(guān)混合鍵合技術(shù)的電學(xué)表征實(shí)驗(yàn)和初步可靠性的研究報告證明,在300mm層疊晶片上,良率達(dá)到100%,在30k菊花鏈時,界面電阻離差較低。儲熱循環(huán)實(shí)驗(yàn)(圖18)結(jié)果證明,技術(shù)成熟的圖像傳感器專用混合鍵合工藝實(shí)現(xiàn)了低電阻離差(小于0.5%)(ST內(nèi)部數(shù)據(jù)待發(fā)布)。

圖18:混合鍵合可靠性實(shí)驗(yàn)結(jié)果。熱循環(huán)(左圖)和儲熱(右圖)測試的電阻離差小于0.5%。
直接鍵合的趨勢:研究人員可能會想出更先進(jìn)的解決方案,例如,3D VLSI CoolCubeTM集成,該方案利用獨(dú)特的連接密度超過百萬/平方毫米的通孔技術(shù),可以垂直堆疊多層芯片,為異質(zhì)集成帶來新的機(jī)遇(高微縮化的像素、CMOS與NEMS混合架構(gòu)、III-V/Ge材料)和設(shè)計靈活性,特別適合于線長微縮或神經(jīng)形態(tài)計算(圖19)。
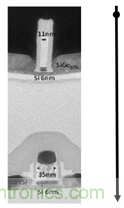
圖19-CoolCubeTM原理
結(jié)論
硅3D集成現(xiàn)已成為現(xiàn)實(shí),是一個高性能的半導(dǎo)體集成創(chuàng)新解決方案,可以替代因光刻技術(shù)投資龐大而在未來十年內(nèi)難以維持經(jīng)濟(jì)效益的標(biāo)準(zhǔn)“摩爾定律”。3D集成被選擇背后的動因是性能、帶寬、復(fù)雜性、互連密度,以及系統(tǒng)微縮化、最終成本和價值鏈。熱管理、熱機(jī)械應(yīng)變和連接密度等難題都已有相應(yīng)的解決辦法。隨著直接混合鍵合套刻精度提高,業(yè)界可能會想出創(chuàng)新的集成方法,替代現(xiàn)有的裸片層疊解決方案,簡化產(chǎn)品價值鏈,開發(fā)出功能分區(qū)、高密度互連的高性能器件。
推薦閱讀:







