【導(dǎo)讀】在DRAM結(jié)構(gòu)中,電容存儲單元的充放電過程直接受晶體管所控制。隨著晶體管尺寸縮小接近物理極限,制造變量和微負(fù)載效應(yīng)正逐漸成為限制DRAM性能(和良率)的主要因素。而對于先進(jìn)的DRAM,晶體管的有源區(qū) (AA) 尺寸和形狀則是影響良率和性能的重要因素。
在DRAM結(jié)構(gòu)中,電容存儲單元的充放電過程直接受晶體管所控制。隨著晶體管尺寸縮小接近物理極限,制造變量和微負(fù)載效應(yīng)正逐漸成為限制DRAM性能(和良率)的主要因素。而對于先進(jìn)的DRAM,晶體管的有源區(qū) (AA) 尺寸和形狀則是影響良率和性能的重要因素。在本研究中,我們將為大家呈現(xiàn),如何利用SEMulator3D研究先進(jìn)DRAM工藝中存在的AA形狀扭曲和與之相關(guān)的微負(fù)載效應(yīng)與制造變量。
AA扭曲及其機(jī)理
領(lǐng)先DRAM制造商幾乎所有已商業(yè)化的DRAM產(chǎn)品都存在AA形狀扭曲。除中心線不穩(wěn)定以外,這種扭曲還體現(xiàn)在切割區(qū)域周邊的關(guān)鍵尺寸差異(見圖1)。

圖1. 三家不同制造商生產(chǎn)的1x DRAM器件的AA剖面圖
圖2為晶體管鰭片刻蝕工藝的簡要示意圖。在鰭片 (AA) 干法刻蝕工藝中,側(cè)壁會因刻蝕副產(chǎn)物的鈍化作用而出現(xiàn)錐形輪廓。由于A點(diǎn)所處區(qū)域需要去除的硅要多于B點(diǎn)所處區(qū)域,A區(qū)域消耗的反應(yīng)物更多,產(chǎn)生的副產(chǎn)物也會更多(見圖2 (b))。這樣,在鰭片刻蝕后,A區(qū)域側(cè)壁的鈍化錐度就要超過B區(qū)域的側(cè)壁(見圖2 (c)),這也就是AA形狀扭曲的原因。
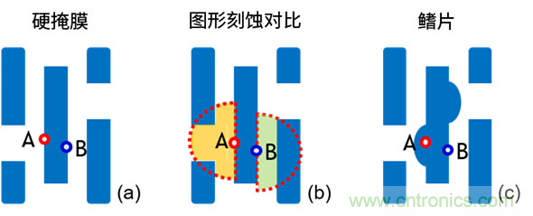
圖2. 鰭片刻蝕工藝中的AA形狀扭曲 (a) 刻蝕前硬掩膜的頂視圖;(b) A、B兩區(qū)域的圖形刻蝕對比;(c) 鰭片刻蝕后的頂視圖
AA扭曲的建模
SEMulator3D采用創(chuàng)新的偽3D方法,實(shí)現(xiàn)基于2D迫近函數(shù)的圖形建模。通過這種建模技術(shù),我們可以創(chuàng)建DRAM器件的3D模型并模擬出AA形狀扭曲現(xiàn)象。圖3展示的是通過SEMulator3D模擬的DRAM 3D結(jié)構(gòu)和平面圖、布局設(shè)計(jì)和圖形相關(guān)掩膜。通過對比可以看出,圖3 (d) 和圖1 (c) 所呈現(xiàn)的AA扭曲形態(tài)是類似的,這證明模型能正確反映實(shí)際制造結(jié)果。圖4展示的是不同鰭片高度的AA剖面圖,從中可以看出結(jié)構(gòu)底部的扭曲幅度要遠(yuǎn)高于器件頂部的扭曲。
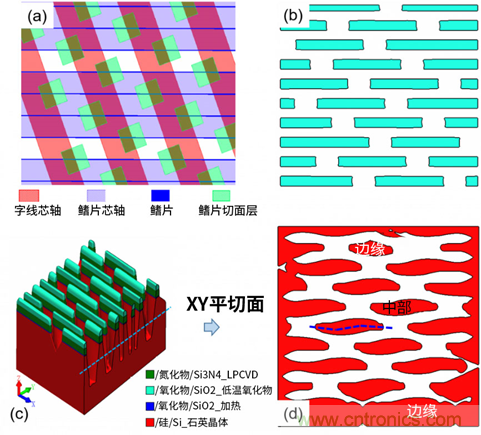
圖3. (a) 布局設(shè)計(jì);(b) 硬掩膜生成的PDE掩膜;(c)鰭片刻蝕后的3D結(jié)構(gòu);(d)來自鰭片中部平面切口的AA形狀

圖4. 不同鰭片高度的AA剖面 (a) 沿字線切開的3D視圖;(b) 沿字線切開的橫截面圖;(c) 沿鰭片頂部切開的3D視圖;(d)沿鰭片中間切開的3D視圖;(e) 沿鰭片底部切開的3D視圖
器件模擬與分析
在具有埋入式字線的DRAM單元中,晶體管通道位于鰭片中部附近,這里的形狀扭曲要比鰭片頂部嚴(yán)重(見圖4 (c)和 (d))。在這種情況下,受側(cè)壁鈍化的影響,該通道下方的鰭片CD也要大很多。
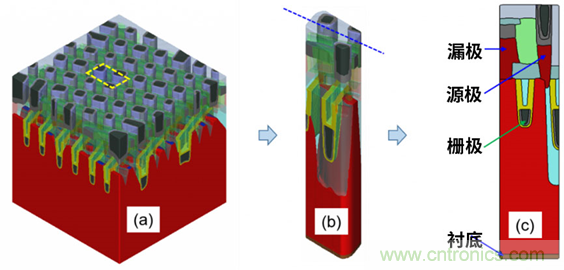
圖5. 電容接觸點(diǎn)形成后的DRAM結(jié)構(gòu) (a) 3D視圖;(b)切出的單器件;(c)鰭片切面和端口定義
為評估AA形狀扭曲對器件性能的影響,我們用SEMulator3D建模了0.1、2.5和5度的側(cè)壁裂角以模擬不同程度的AA扭曲,并使用來自全環(huán)路DRAM結(jié)構(gòu)的單個器件進(jìn)行了電氣分析(見圖5 (b))。通過SEMulator3D分配電端口(源極、漏極、柵極和襯底)即可獲得電氣測量值(見圖5 (c)),之后使用SEMulator3D內(nèi)置漂移/擴(kuò)散求解器即可計(jì)算不同程度AA扭曲可能導(dǎo)致的電氣性能變化。
圖6展示的是不同側(cè)壁角度下鰭片的斷態(tài)漏電流分布??梢钥闯?,無論側(cè)壁角度如何,大部分漏電流集中在鰭片的中心,它們遠(yuǎn)離柵極金屬,柵極電場對其沒有太大影響。由于厚鰭(側(cè)壁角度較大)的柵極可控性更低,其漏電流密度要遠(yuǎn)高于更薄的鰭片。

圖6. 從鰭片表面到中心在不同側(cè)壁角度下的通道泄漏形態(tài)
總結(jié)
本研究使用SEMulator3D建模和分析了先進(jìn)DRAM工藝中的晶體管微負(fù)載效應(yīng)。分析結(jié)果表明,圖形相關(guān)刻蝕中的微負(fù)載效應(yīng)會導(dǎo)致AA形狀扭曲,這種微負(fù)載效應(yīng)將嚴(yán)重影響器件的電氣性能,其中涉及的斷態(tài)泄漏更是決定DRAM單元數(shù)據(jù)保留能力的關(guān)鍵因素。
免責(zé)聲明:本文為轉(zhuǎn)載文章,轉(zhuǎn)載此文目的在于傳遞更多信息,版權(quán)歸原作者所有。本文所用視頻、圖片、文字如涉及作品版權(quán)問題,請電話或者郵箱聯(lián)系小編進(jìn)行侵刪。







