【導讀】報道了基于分子束外延的短/中波雙色碲鎘汞材料及器件的最新研究進展。采用分子束外延方法制備出了高質(zhì)量的短/中波雙色碲鎘汞材料,并通過提高材料質(zhì)量將其表面缺陷密度控制在300 cm-2以內(nèi)。在此基礎上進一步優(yōu)化了芯片制備工藝,尤其是在減小像元中心距方面作了優(yōu)化。基于上述多項材料及器件工藝制備出了320 × 256短/中波雙色碲鎘汞紅外探測器組件。結(jié)果表明,該組件的測試性能及成像效果良好。
摘要
報道了基于分子束外延的短/中波雙色碲鎘汞材料及器件的最新研究進展。采用分子束外延方法制備出了高質(zhì)量的短/中波雙色碲鎘汞材料,并通過提高材料質(zhì)量將其表面缺陷密度控制在300 cm-2以內(nèi)。在此基礎上進一步優(yōu)化了芯片制備工藝,尤其是在減小像元中心距方面作了優(yōu)化?;谏鲜龆囗棽牧霞捌骷に囍苽涑隽?20 × 256短/中波雙色碲鎘汞紅外探測器組件。結(jié)果表明,該組件的測試性能及成像效果良好。
0 引言
隨著紅外探測器應用范圍的不斷擴展和紅外隱身技術(shù)水平的日益提高,人們期望在更為復雜的背景及環(huán)境下實現(xiàn)高精度的高速紅外探測,同時提高識別準確率。雙/多色紅外焦平面探測器組件可通過多波段對比去除干擾信號,從而更為有效地提取目標信息,因此具有迫切、廣泛的應用需求。其中,短/中波雙色紅外焦平面探測器組件不僅在導彈預警、氣象探測、資源遙感等方面有著明確需求,而且還在機載偵察系統(tǒng)、低空地空導彈光電火控系統(tǒng)、精確制導武器等方面具有廣闊的應用前景。
本文報道了中國電子科技集團公司第十一研究所(以下簡稱“中國電科11所”)在短/中波雙色碲鎘汞紅外探測器組件研制方面的最新進展:通過分子束外延技術(shù)獲得了高質(zhì)量短/中波雙色碲鎘汞材料;芯片采用半平面雙注入結(jié)構(gòu),其I-V性能良好;再經(jīng)過讀出電路互聯(lián)和封裝工藝,形成了短/中波雙色器件;在80 K的工作溫度下,對探測器組件進行了光電性能表征及成像試驗,獲得了良好的成像效果。
1 材料生長及器件制備
采用芬蘭DCA儀器公司生產(chǎn)的P600型分子束外延系統(tǒng)制備雙色材料,即在襯底材料上分別外延短波碲鎘汞吸收層、高組分碲鎘汞阻擋層、中波碲鎘汞吸收層以及碲化鎘鈍化層。芯片采用半平面雙注入結(jié)構(gòu)(示意圖和版圖分別見圖1和圖2)。經(jīng)過鈍化、退火、光刻、注入、刻蝕、電極生長等工藝后,完成短/中波雙色芯片的制備。該芯片與硅讀出電路進行倒裝互聯(lián),然后被封裝到真空杜瓦中,并耦合制冷機,從而形成完整組件。
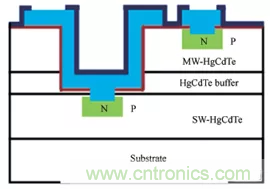
圖1 半平面雙注入結(jié)構(gòu)的示意圖
采用光學顯微鏡對雙色材料的表面缺陷密度進行統(tǒng)計,然后通過I-V測試以及掃描電子顯微鏡(Scanning Electron Microscope,SEM)對芯片進行表征。組件測試在80 K溫度下進行,主要包括探測率、盲元率、非均勻性等方面。最后對雙色組件進行成像演示。

圖2 芯片版圖的示意圖
2 材料及芯片工藝的優(yōu)化
2.1 材料性能優(yōu)化設計
在現(xiàn)有的短/中波雙色碲鎘汞材料工藝中,作為首先生長的吸收層,短波層的材料質(zhì)量直接影響雙色材料的質(zhì)量。尤其是由短波層生長引入的缺陷在經(jīng)過阻擋層和中波吸收層放大后,極易在雙色碲鎘汞材料表面上引入直徑大于10 μm的缺陷,從而增加雙色器件的盲元率。
為降低短波碲鎘汞材料的缺陷密度和提高材料質(zhì)量,我們對硅基短波碲鎘汞材料生長工藝進行了專項研究。分子束外延碲鎘汞材料的缺陷密度主要與外延溫度、PHg/PTe束流比、生長速率三個工藝參數(shù)相關(guān)。根據(jù)三者之間的關(guān)系,設計了正交試驗。根據(jù)正交試驗表格,對三因子(外延溫度、PHg/PTe束流比、生長速率,其中PTe與生長速率一一對應,PHg/PTe束流比可簡化為PHg)設計了三水平的試驗。正交表格采用L9(34),見表1。設計的三水平參數(shù)值見表2。
2.2 材料優(yōu)化數(shù)據(jù)分析
我們主要采用極差分析法對正交試驗結(jié)果進行分析,其原理是將正交試驗各個影響因素所對應的極差值進行比較。根據(jù)相關(guān)理論可知,如果某因素所對應的極差值較大,那么該因素就是正交試驗中的主要因素;反之,該因素則是正交試驗中的次要因素。因此,可根據(jù)極差值的大小來判斷影響因素的主次。

表1 L9(34)正交表

表2 三因子三水平參數(shù)值表
針對本次試驗,所有樣品均取自同一個生長周期,以排除由分子束外延設備因素造成的影響;取材料組分及厚度相近的樣品,以排除材料參數(shù)的影響。將9個樣品的材料參數(shù)作為參考樣本(詳見表3),同時將缺陷密度值作為分析數(shù)據(jù),得到了表4。
表4中的數(shù)據(jù)清楚地表明了各因素對材料缺陷的影響。生長溫度所對應的極差值最大,說明在碲鎘汞材料的分子束外延過程中,生長溫度對試驗結(jié)果的貢獻最大,直接決定了材料缺陷密度;其次是生長速率,它在本次試驗中的作用雖不及生長溫度,但在材料缺陷密度方面的影響更大些,因此可判斷生長速率對材料缺陷密度的變化起到了至關(guān)重要的作用。三個因素中,Hg流量所對應的極差值均是最小的,所以它對試驗結(jié)果的影響最小,但也大于誤差項。這說明Hg流量對材料缺陷的形成有一定的影響,但是其影響要小于生長溫度和生長速率。因此,在研究碲鎘汞材料生長工藝的過程中,主要工作應該放在生長溫度和生長速率方面,而且尋找和應用合適的碲鎘汞材料生長溫度及其相應降溫曲線的生長速率是工藝優(yōu)化中的關(guān)鍵。
(1)對于因素1:當生長溫度為220℃時,缺陷密度最小,因此可認為最優(yōu)的生長溫度應該是220℃。
(2)對于因素2:缺陷密度的最優(yōu)值在51 sccm時取得;以缺陷密度為優(yōu)先考量因素,最優(yōu)的Hg流量應該是51 sccm。
(3)對于因素3:缺陷密度在1.5 μm/h時獲得最優(yōu)值,因此在本次試驗中,1.5 μm/h是最適合工藝中降溫曲線的生長速率。但是該試驗沒有獲得生長速率對材料缺陷影響的拐點處。在今后的工藝中,可繼續(xù)降低生長速率,以獲得最優(yōu)的生長速率值。
通過對生長溫度、Hg流量、生長速率三個關(guān)鍵材料工藝參數(shù)進行優(yōu)化,將短/中波雙色材料的缺陷密度從500 cm-2優(yōu)化到300 cm-2,為最終組件減少盲元奠定了良好的基礎。圖3為碲鎘汞雙色材料表面的顯微鏡照片。
2.3 芯片工藝優(yōu)化
探測器芯片具有半平面雙注入結(jié)構(gòu)。采用高密度等離子體干法刻蝕工藝制備短波臺面,然后使用多腔室磁控濺射系統(tǒng)在表面上生長ZnS/CdTe復合膜層,并對其進行鈍化處理。通過注入B離子同時對中短波結(jié)構(gòu)進行摻雜來形成p-n結(jié),接著利用Cr/Au/Pt電極體系完成芯片電學性能的引出。其他的工藝步驟(如標記刻蝕、離子注入、退火、金屬化等)與業(yè)內(nèi)平面型單色碲鎘汞器件工藝基本一致。本文研制的320 × 256短/中波雙色芯片的像元中心距為30 μm,而前期芯片的像元中心距為50μm,這就在深臺面刻蝕、側(cè)壁鈍化等工藝方面提出了更高的要求。

表3 試驗樣品參數(shù)

表4 樣品缺陷密度正交試驗結(jié)果的分析表

圖3 碲鎘汞雙色材料表面的放大圖(200倍)
2.3.1 深臺面刻蝕優(yōu)化
深臺面刻蝕采用的是基于CH4和H2工藝的干法刻蝕工藝。其中,聚合物的生成及排出的動態(tài)關(guān)系是決定深臺面刻蝕效果好壞的重要因素。隨著刻蝕的進行,臺面深度增大,揮發(fā)性生成物的排出速率受到影響。若排出速率過慢,生成物就會在臺面底部積聚成固態(tài)聚合物。這將影響深微臺面的形貌及深度均勻性。同時,刻蝕工藝的橫向刻蝕還會對臺面陡度造成重要影響。若陡度過小,則臺面底部孔的尺寸過小,直接影響到注入?yún)^(qū)以及接觸孔的實際尺寸。在后續(xù)工藝完成后,有可能導致盲元產(chǎn)生。通過調(diào)節(jié)刻蝕工作壓力和氣體配比來降低微負載效應,可以提升刻蝕均勻性,同時還可在刻蝕形貌和臺面陡度方面達到平衡。
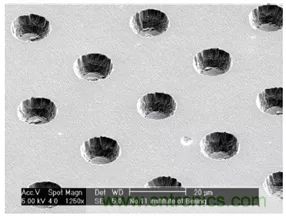
圖4 芯片表面的SEM照片
在刻蝕側(cè)壁損傷方面,采用干法混合刻蝕技術(shù)并通過分時段調(diào)整刻蝕工藝參數(shù)來加以控制。在刻蝕工藝末端采用低刻蝕偏壓,以降低刻蝕過程對深臺面?zhèn)缺诩暗酌娴膿p傷。通過工藝優(yōu)化和驗證,獲得了良好的刻蝕效果(見圖4)。
2.3.2 側(cè)壁鈍化工藝優(yōu)化
器件鈍化工藝采用CdTe和ZnS復合膜層。它的難點在于,與主流的平面型碲鎘汞器件不同,雙色器件的鈍化還包含深臺面的側(cè)壁鈍化,即通過對濺射工藝參數(shù)進行調(diào)整和優(yōu)化,實現(xiàn)器件鈍化和臺面覆蓋的雙重效果。利用聚焦離子束掃描電子顯微鏡(Focused Ion Beam Scanning Electron Microscopy,F(xiàn)IB-SEM)觀察了干法刻蝕后的深臺面底部形貌和側(cè)壁鈍化效果。從圖5(a)中可以看出,用高密度等離子體干法刻蝕工藝制備的深臺面底部平滑,沒有聚合物及生成物產(chǎn)生,為制備性能良好的短波p-n結(jié)奠定了重要基礎;從圖5(b)中可以看出,使用多腔室磁控濺射系統(tǒng)在表面上生長的ZnS/CdTe復合膜層可將側(cè)壁完全覆蓋,這對抑制p-n結(jié)漏電流起到了重要作用。
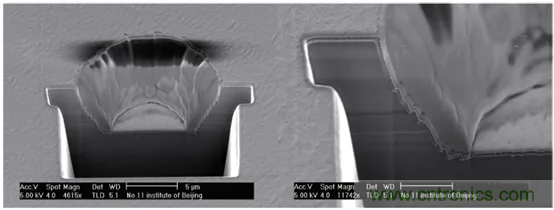
圖5 芯片側(cè)壁鈍化后的SEM照片
2.4 芯片優(yōu)化結(jié)果分析
利用半導體參數(shù)分析儀對芯片的I-V特性進行測試。將芯片放置在液氮環(huán)境中,然后從制備的面陣芯片邊緣隨機選取測試管芯。如圖6所示,中短波的I-V特性與硅基單色器件基本一致,說明芯片p-n結(jié)表現(xiàn)出了較高的I-V性能,并且具備較好的品質(zhì)因子。

圖6(a)中波p-n結(jié)的I-V性能測試結(jié)果;(b)短波p-n結(jié)的I-V性能測試結(jié)果
2.5 混成芯片制備
320 × 256短/中波雙色芯片需與讀出電路通過倒裝互連來完成制備。圖7為In柱生長后讀出電路的SEM照片。碲鎘汞器件與讀出電路通過倒裝互連進行電連接,經(jīng)背增透后形成碲鎘汞雙色混成芯片。
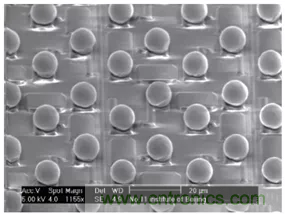
圖7 In柱生長后讀出電路的SEM照片
3 組件性能表征
320 × 256短/中波雙色芯片通過倒裝互連與讀出電路耦合,然后經(jīng)退火回流工藝處理,并被裝入到真空杜瓦中,從而形成短/中波雙色組件。在液氮溫度下,使用PI紅外焦平面測試系統(tǒng)對該組件進行了測試。結(jié)果表明,它在中波波段的盲元率、峰值探測率和響應率不均勻性分別為1.47%、2.13 × 1011 cm·Hz1/2/W和4.22%,在短波波段的盲元率、峰值探測率和響應率不均勻性分別為0.88%、2.23 × 1012 cm·Hz1/2/W和3.85%。圖8所示為該組件的成像結(jié)果。可以看出,中國電科11所目前研制的短/中波雙色組件性能良好,基本可達到實用化要求;后續(xù)將根據(jù)用戶的具體需求,有針對性地對盲元率(連續(xù)盲元)和噪聲等效溫差(中波)等指標進行優(yōu)化。

圖8 短/中波雙色組件的成像圖
4 結(jié)論
在像元中心距為50 μm的128 × 128短/中波雙色組件的基礎上,通過對材料及芯片制備工藝進行優(yōu)化,獲得了缺陷密度更低的高質(zhì)量短/中波雙色碲鎘汞薄膜材料以及像元中心距更?。?0 μm)、性能更高的320 × 256短/中波雙色碲鎘汞芯片。測試及成像結(jié)果表明,320 × 256短/中波雙色制冷組件的性能基本可達到實用化要求,且兩個波段成像清晰。后續(xù)研究正在進行中,主要集中在更大面陣、更高信噪比、更低盲元率(中心區(qū)域無連續(xù)盲元)三個方向上,并將在以后的論文中介紹詳細的研制進展。
免責聲明:本文為轉(zhuǎn)載文章,轉(zhuǎn)載此文目的在于傳遞更多信息,版權(quán)歸原作者所有。本文所用視頻、圖片、文字如涉及作品版權(quán)問題,請電話或者郵箱聯(lián)系小編進行侵刪。








