【導讀】隨著ADC和DAC的性能規(guī)格、形狀參數(shù)和新的傳感器技術(Rx和Tx)的不斷發(fā)展,RF數(shù)據(jù)轉換系統(tǒng)正在發(fā)生快速變化。在這期間,一個系統(tǒng)級的設計問題一直存在,即如何平衡模擬和數(shù)字電路的設計,以實現(xiàn)最大的軟件/系統(tǒng)靈活性(從傳感器到數(shù)字處理單元的輸入/輸出)。
摘要
隨著ADC和DAC的性能規(guī)格、形狀參數(shù)和新的傳感器技術(Rx和Tx)的不斷發(fā)展,RF數(shù)據(jù)轉換系統(tǒng)正在發(fā)生快速變化。在這期間,一個系統(tǒng)級的設計問題一直存在,即如何平衡模擬和數(shù)字電路的設計,以實現(xiàn)最大的軟件/系統(tǒng)靈活性(從傳感器到數(shù)字處理單元的輸入/輸出)。這個基本問題需要系統(tǒng)設計師劃分(或組合)數(shù)據(jù)轉換電路器件,并結合模擬和數(shù)字信號的布線,實現(xiàn)多種服務的軟件最大化?,F(xiàn)在,隨著高級的SiP(系統(tǒng)級封裝)組裝技術的發(fā)展,數(shù)據(jù)轉換器系統(tǒng)的設計正逐步從硬件中心向軟件中心轉變。Teledyne e2v的SiP設計、發(fā)展和組裝的專業(yè)技術革新了系統(tǒng)級設計,可實現(xiàn)最大的靈活性并支持多任務的應用。利用最先進的技術(倒裝芯片、有機封裝等)開發(fā)的RF混合信號數(shù)字處理應用可用于工業(yè)、醫(yī)療、航空電子、儀器、電信、軍事和宇航等應用。Teledyne e2v在高級SiP設計和組裝技術方面擁有超過40年的經(jīng)驗,可幫助系統(tǒng)設計師實現(xiàn)高級數(shù)據(jù)轉換系統(tǒng)平臺的最高性能和最大價值。
用于SiP設計的高級數(shù)據(jù)轉換器件
高頻數(shù)據(jù)轉換器系統(tǒng)需要高性能(和可靠的)半導體器件來處理整個信號鏈的關鍵功能。選擇可以滿足整個系統(tǒng)性能要求的合適的半導體器件對SiP的實現(xiàn)至關重要。Teledyne e2v為SiP的實現(xiàn)提供了高速數(shù)據(jù)轉換器、微處理器、存儲器以及各種模擬和邏輯功能器件。
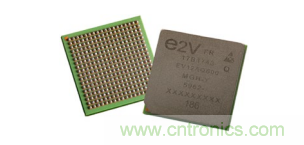
顯然,數(shù)據(jù)轉換接收(Rx)系統(tǒng)的核心器件是ADC。Teledyne e2v在過去的20多年里一直致力于數(shù)據(jù)轉換器技術的創(chuàng)新,并提供了多通道、低噪聲、低失真的微波頻率ADC(如上圖的EV12AQ600)。這種數(shù)據(jù)轉換器使系統(tǒng)設計師能(通過直接RF轉換)消除傳統(tǒng)架構中下變頻所需的模擬環(huán)節(jié)。利用Teledyne e2v的高端ADC減少模擬環(huán)節(jié),并使用高級的SiP設計技術配合無需許可證的標準和定制解決方案,設計師可以研發(fā)許多標準產(chǎn)品和定制產(chǎn)品,以滿足特定的性能和/或環(huán)境需求。
未來高速SiP直接RF數(shù)據(jù)轉換接收(Rx)方案的核心是EV12AQ600。結合RTH120跟蹤保持放大器(THA),PS620實驗SiP RF前端接收板(如下圖所示)的性能非常優(yōu)秀(見第2頁上器件的核心參數(shù))。EV12AQ600是一款四核ADC,包含交叉點開關(CPS)前端,允許四個ADC核心同時、獨立或成對地工作,支持四通道1.6Gsps,兩通道3.2Gsps或單通道6.4Gsps的采樣率。典型的四通道模式的SFDR(不考慮H2和H3諧波)優(yōu)于70dBFS(-1dBFS輸出,頻率高達5980MHz)。

這款器件可提供多種級別,包括商業(yè)級、工業(yè)級、軍級,最高支持耐輻射宇航級。EV12AQ600可用于多種應用,如高速數(shù)據(jù)采集、高速測試儀器、自動測試設備、地球觀測SAR雷達載荷、電信MIMO衛(wèi)星載荷、超寬帶衛(wèi)星數(shù)字接收機、C波段直接RF轉換、微波軟件定義無線電、點對點微波接收端、機器狀態(tài)監(jiān)測系統(tǒng)、飛行時間質譜分析、LiDAR、高能物理等。
器件核心參數(shù)
EV12AQ600 ADC:
• 四個12-bit 1.6 GSps ADC核心,支持1、2或4通
道時域交織
• 全交織模式采樣率高達6.4 GSps
• 6.5 GHz輸入帶寬(-3dB)
• 集成的寬帶交叉點開關
• 支持多通道同步的同步鏈
RTH120 THA:
• 24GHz 輸入帶寬
• 雙THA使輸出保持時間超過半個采樣時鐘周期
• 全差分設計
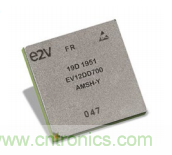
在實現(xiàn)高速、最先進的SiP數(shù)據(jù)轉換發(fā)射端(Tx)解決方案方面,關鍵的技術是EV12DD700(如右圖所示)。該雙路12位DAC支持高達12Gsps的采樣率,可直接產(chǎn)生高達21GHz的輸出信號,滿刻度階躍響應時間低至15ps,在微波頻率的噪聲很低,性能優(yōu)秀。EV12DD700雙通道DAC也支持Ka波段工作,支持波束形成的應用。這款DAC有25GHz的3dB輸出帶寬,即使超過25GHz也僅有略大于3dB的衰減(見下圖)。每個DAC都集成了一系列復雜的信號處理功能,包括一個用于直接數(shù)字合成(DDS)功能的可編程anti-sinc濾波器,一個可編程的復雜混頻器,以及一個包含四個插值環(huán)節(jié)的數(shù)字上變頻器。數(shù)字處理功能包括:插值(4x, 8x和16x)、帶有數(shù)字控制振蕩器(32位NCO)的數(shù)字上變頻(DUC)、直接數(shù)字合成(DDS)、數(shù)字波束形成和波束跳變。DAC的主要功能包括:可編程輸出模式(NRZ, RF, 2RF)、增益調節(jié)、可編程SINC補償功能和多器件同步。
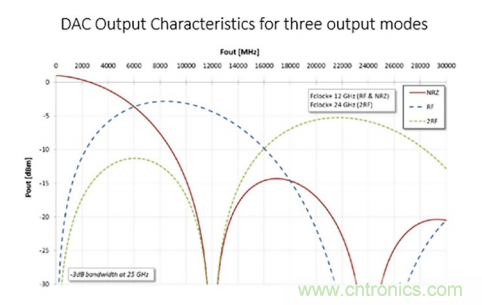
圖 1
當然,所有的高速數(shù)據(jù)轉換系統(tǒng)也需要先進的數(shù)字處理能力。例如,Teledyne e2v已經(jīng)認證并發(fā)布了一款從NXP最新的Layerscape® 系列篩選出的微處理器LS1046A,可工作在-55℃到125℃(宇航級LS1046-Spacce也很快會發(fā)布)。LS1046A是NXP的64位ARM® Layerscape產(chǎn)品系列的一款器件,使用四核ARM® Cortex® A72設計。
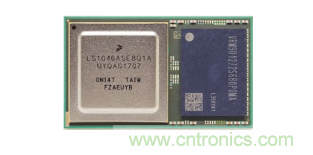
這種設計在盡可能小的封裝里實現(xiàn)了無與倫比的性能。用戶可以使用與ARM® 技術兼容的龐大的軟件、應用、工具的生態(tài)系統(tǒng)。LS1046A是一款1.8GHz的處理器,集成了包處理加速和高速外設,使用了高性能的架構,有業(yè)內(nèi)領先的計算密度。其超過45,000CoreMarks® 的計算性能(即30K DMIPS@1.8GHz),搭配雙路10Gb以太網(wǎng)、3路PCIe Gen3和1路SATAGen3,適用于一系列高可靠性的軍用、航空和航天的應用。LS1046A也集成到了Teledyne e2v最新的Qormino® 計算模塊中,這個模塊還包含了一個4GB的DDR4存儲器(見左側的照片)。此外,作為Teledyne e2v的半導體生命周期管理計劃SLiM™的一部分,這款器件的生命周期可達15年以上,避免了常見的昂貴的器件過時問題。
數(shù)據(jù)轉換SiP實現(xiàn)峰值系統(tǒng)性能:適用于所有細分市場
在工業(yè)、醫(yī)療、飛行電子、儀器、電信、軍事和宇航領域,數(shù)據(jù)轉換系統(tǒng)正在經(jīng)歷快速的變化。對于所有的細分市場,首要的系統(tǒng)級設計問題是,如何在模擬和數(shù)字電路之間取得平衡,實現(xiàn)最大的軟件/系統(tǒng)靈活性(從傳感器到計算機輸入或從計算機輸出到傳感器)。這個基本的問題要求系統(tǒng)設計師劃分(或組合)數(shù)據(jù)轉換電路器件,并結合模擬和數(shù)字信號的布線,以實現(xiàn)多種服務的軟件最大化。
系統(tǒng)工程師了解他們的市場、應用和電路性能的規(guī)范需求,但設計參數(shù),例如風險、技術選擇、形狀參數(shù)、開發(fā)時間表(包括時間表同步)、可靠性,以及與高性能數(shù)據(jù)轉換系統(tǒng)相關的成本,都是高度可變的。這些設計參數(shù),加上不斷變化的系統(tǒng)性能規(guī)格需求,最終導致更窄的設計實現(xiàn)“交集”(圖2)。
當然,在任何設計參數(shù)上犯錯誤,都會付出巨大的代價。因此,任何可以嵌入到設計開發(fā)中的靈活性,只要能為項目增加整體價值而不是降低價值,都是值得投資的。

圖 2 - 不斷增加的設計參數(shù)和系統(tǒng)級性能需求,產(chǎn)生了更窄的“交集”。
有一個設計參數(shù)可以提高設計階段的靈活性,并最終滿足必要的性能需求,特別是對于數(shù)據(jù)轉換系統(tǒng)。它是利用SiP(系統(tǒng)級封裝)技術實現(xiàn)所需的功能。過去,半導體工藝技術的不斷進步使系統(tǒng)級設計師能夠在SoC(片上系統(tǒng))上實現(xiàn)完整的電路功能。隨著門電路長度縮短至10nm甚至更小,需要大量數(shù)字計算的SoC應用已可以通過半導體技術實現(xiàn)。不幸的是,隨著半導體特征尺寸的減小,芯片的開發(fā)成本呈指數(shù)級
增長(見圖3)。
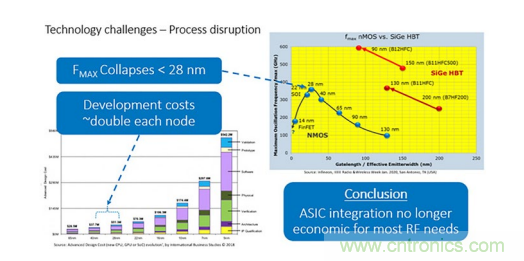
圖 3
圖3也顯示了最小幾何門尺寸和最大器件振蕩頻率之間的相關性。如圖所示,F(xiàn)max的拐點在門長度<28nm的位置。相應的,隨著門長度的減小,開發(fā)成本呈指數(shù)增長(G=28nm(平均開發(fā)成本5130萬美元),G=16nm(平均開發(fā)成本1.063億美元),G=7nm(成本2.97億美元),G=5nm(成本超過5億美元))。隨著SoC包含更多的功能,需要使用更小的門長度,其開發(fā)的成本變得令人望而卻步。例如,SoC一直是移動電話行業(yè)的驅動技術,但對模擬技術(如MEMS傳感器)的需求不斷增加,導致從SoC到SiP方案的變革。圖4說明了當前推進從SoC到SiP的變革的三個共存的設計參數(shù):1)技術:為最優(yōu)系統(tǒng)性能選擇最合適的工藝技術(即Si、GaAs、GaN、SiGe等),2)小型化,3)成本。

圖 4
推動數(shù)據(jù)轉換系統(tǒng)從SoC向SiP發(fā)展的另一個因素是對數(shù)據(jù)轉換電路器件的劃分(或組合)以及模擬和數(shù)字信號的布線,這將允許對多種服務進行最大程度的軟件化。簡單來說,數(shù)據(jù)轉換系統(tǒng)可以設計為“集中式”或“分隨著SoC包含更多的功能,需要使用更小的門長度,其開發(fā)的成本變得令人望而卻步。例如,SoC一直是移動電話行業(yè)的驅動技術,但對模擬技術(如MEMS傳感器)的需求不斷增加,導致從SoC到SiP方案的變革。圖4說明了當前推進從SoC到SiP的變革的三個共存的設計參數(shù):1)技術:為最優(yōu)系統(tǒng)性能選擇最合適的工藝技術(即Si、GaAs、GaN、SiGe等),2)小型化,3)成本。

圖 5
因此,Teledyne e2v的高級的SiP設計、開發(fā)和組裝的專業(yè)技術使數(shù)據(jù)轉換系統(tǒng)的開發(fā)發(fā)生了巨大的變革,實現(xiàn)了多任務應用設計參數(shù)的最大靈活度(即組合和劃分)。通過使用最先進的技術(焊線、倒裝芯片等),組合(或劃分)RF、混合信號和數(shù)字處理半導體,高級的SiP設計和組裝技術能為系統(tǒng)設計師帶來最高性能、最低成本的高頻數(shù)據(jù)轉換系統(tǒng)平臺。
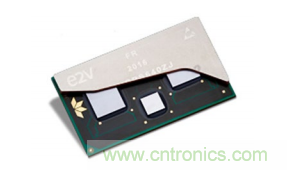
圖 6a
例如,圖6的PS640是一款SiP實現(xiàn)的RF數(shù)據(jù)轉換系統(tǒng)產(chǎn)品,目前正在研發(fā),用于未來的L波段到Ka波段的頻率接收機(1GHz至40GHz)。PS640使用Teledyne e2v基于STMicro BiCMOS055工藝設計的新型THA和兩片互相交織的EV12AQ600 ADC,是一款“集中式”的高速SiP數(shù)據(jù)轉換接收器(Rx)。圖6也描述了其性能指標。圖7描述了一種相同的數(shù)據(jù)轉換系統(tǒng)的未來概念,這是一種“分布式”數(shù)據(jù)轉換接收器的實現(xiàn)方式,使用光引擎(包含在SiP中)驅動數(shù)字處理器(FPGA),實現(xiàn)最大軟件化(軟件中心)。
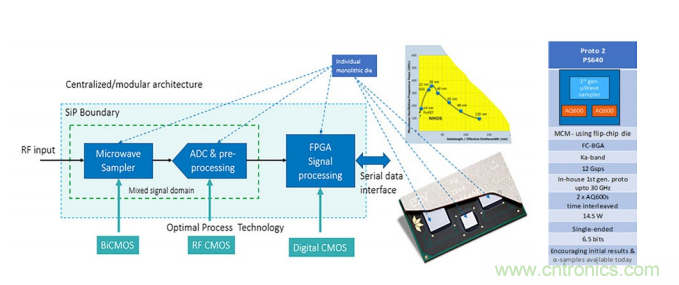
圖 6b
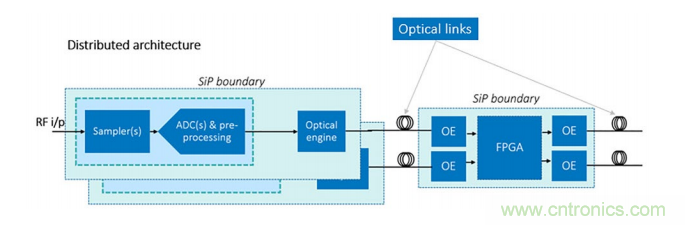
圖 7
TE2V的高級SiP組裝技術
SiP是將多個器件(主動器件或被動器件)封裝在一起的單個設備。SiP用于在電子系統(tǒng)層面執(zhí)行多項功能。嵌入在SiP中的半導體器件(包括被動器件)可以水平和/或垂直堆疊在基材上,然后進行封裝。半導體可以通過焊線或焊接凸點的方式與基材連接(也可以用于將裸片堆疊成垂直的結構)。如前所述,數(shù)據(jù)轉換SiP可能包含多個裸片,如前置放大器、混頻器、ADC、DAC,專用處理器、存儲集成電路和被動器件(如電阻和電容)。這些裸片是使用不同的安裝技術固定在同一個基材上。SiP的組裝技術促進了細分市場的發(fā)展,特別是與超高RF(地面和非地面)、需要MEMs電路的物聯(lián)網(wǎng)(IOT)、移動和可穿戴設備等應用相關的領域。憑借一系列的使用SiP技術的產(chǎn)品和封裝解決方案,Te2v為工業(yè)、醫(yī)療、航空、軍事、科學和空間等應用的細分市場提供設計和組裝服務。此外,Teledyne e2v的許多產(chǎn)品都是通過與NXP、Everspin、Micron等公司的戰(zhàn)略合作開發(fā)的。
Te2v可提供一系列SiP設計開發(fā)的供應鏈管理服務,包括:裸片設計、封裝設計、高可靠組裝、高性能速度測試、質量服務和半導體生命周期管理(SLiMTM,見圖 8)。Te2v擁有超過40年的宇航設計經(jīng)驗,包括ADC、DAC、微處理器、存儲器以及內(nèi)部測試和質量服務,能為所有細分市場提供滿足任何質量等級需求的高級SiP的產(chǎn)品和服務。Te2v的高級的SiP組裝技術包括:焊線、倒裝芯片、有機和陶瓷封裝(密封和非密封)以及混合組裝。

圖 8
當然,在組裝之前,高級高速SiP開發(fā)需要封裝仿真和封裝參數(shù)的測試,以評估散熱和可靠性。例如,圖9介紹了上文提到的PS640的熱仿真。對于散熱設計,將多個裸片緊密地放置在一起是一個挑戰(zhàn)。為了準確預測器件最關鍵區(qū)域的結溫,需要進行仔細的熱仿真。
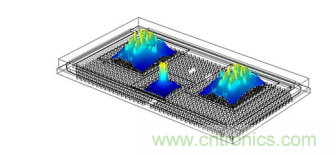
圖 9 - PS640 SiP的熱仿真
Te2v使用與設計師和客戶討論商定的邊界條件,使仿真的性能匹配最終的測試結果(這對于SiP集成的關鍵
器件是必需的)。此外,Te2v使用高頻3D場解算器(Ansys HFSS)對RF SiP的開發(fā)進行仿真和設計。HFSS是一款用于電磁結構的商業(yè)有限元方法解算器,適用于SiP封裝包含的復雜RF電子電路/半導體器件、濾波器、傳輸線的封裝設計(見圖 10)。

圖 10 - 對 PS640 進行 40GHz 模擬輸入的 3D 場解算器仿真 (Ansys HFSS) 顯示封裝到 THA 的裸片之間的連接狀況,并分析了硅金屬填充里的信號傳遞。
在這個例子里,Te2v的封裝團隊和負責Te2v的SiP開發(fā)流程的半導體團隊共同設計了這個RF模擬前端。由于嵌入在單個有機基材里的硅技術有所不同,以及C4(受控塌陷芯片連接 - 倒裝芯片凸點)和C5(焊球)機電接口中的RoHS焊點,SiP設計的可靠性是一個重大的工程挑戰(zhàn)。Te2v不斷開發(fā)新技術,通過熱機械分析,并考慮諸如焊料蠕變和粘塑性等的非線性行為,快速并準確地預測產(chǎn)品的翹曲和板級的可靠性
(見圖11)。
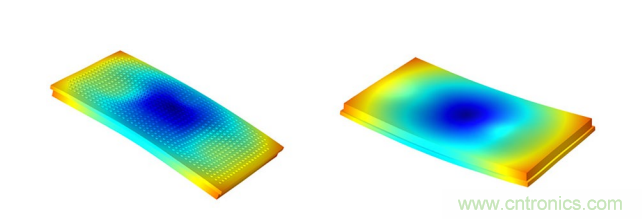
圖 11 - PS640 在室溫組裝后發(fā)生的封裝翹曲的 50 倍放大圖
具體的設計和組裝服務還包括:定制產(chǎn)品、中/低用量產(chǎn)品、高可靠/高端產(chǎn)品、QML-V/QML-Y認證以及宇航認證(參考圖12中的技術總結):

圖 12 - Te2v 的高級組裝技術,可用于 SIP 的組裝
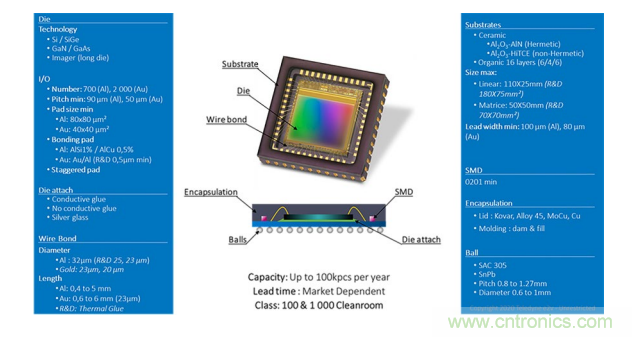

圖 13 - Te2v 的高級焊線(上)和倒裝芯片(下)技術,可用于 SIP 的組裝
圖13說明了Te2v的高級SiP焊線和倒裝芯片組裝技術。對于焊線,圖13(上圖)說明了滿足不同半導體類型(Si、GaN、GaAs等)和封裝類型的最新發(fā)展所需的眾多組裝技術。隨著新一代的半導體和封裝的發(fā)布,必須開發(fā)新的焊線技術,以滿足性能的要求。焊線大約占所有電子封裝組裝(包含flash存儲器和傳感器等)的三分之二。對于一些硅節(jié)點,如MEMS傳感器,無法使用先進的倒裝芯片互聯(lián)技術。在這些情況下,焊線依然具有成本和可靠性方面的優(yōu)勢。
倒裝芯片技術(也如圖13所示)基于半導體頂部形成的一系列凸起或銅柱。倒裝芯片的流程和傳統(tǒng)IC的制造類似,只需要增加幾個步驟。在制造過程接近尾聲時,對焊盤進行金屬化或焊料預處理,使其更容易焊接。在最后的晶圓流程中,焊接凸起會在晶圓頂部的
芯片焊盤上形成,然后像往常一樣從晶圓上切下芯片。為了將芯片安裝在外部電路(SiP電路板和/或另一個芯片或裸片)上,需要翻轉芯片使其頂部朝下,并使它的焊盤與外部電路的焊盤對齊,然后進行回流焊(通常使用熱超聲焊接或回流焊接),以使它們互相連接。這會在芯片電路和底部之間留下了一個很小的空間。在很多情況下,需填充電氣絕緣的粘合劑,以保證更強的機械連接,并產(chǎn)生熱橋,確保焊點不會由于芯片和系統(tǒng)的其他部分的熱量不同而受到應力。這些填充物減少了芯片和板子之間的熱膨脹系數(shù)的不匹配帶來的影響,防止應力集中于焊點,防止器件過早失效。倒裝芯片技術與焊線技術不同,在焊線技術中,芯片被簡單地安裝,然后用線將芯片的焊盤和外部電路連接起來。
TE2V:為高級SiP的設計和組裝提供一站式服務
在性能生命周期內(nèi),SiP可降低特定產(chǎn)品和系統(tǒng)的總體成本,特別是與其他設計選項(如SoC等)相比時。SiP可在產(chǎn)品生命周期的各個階段減少總體的系統(tǒng)開發(fā)成本,如:
1. 降低工程成本:在工程開發(fā)時間、材料和上市時間方面顯著降低設計的難度。
2. 降低PCB成本:簡化特定器件的開發(fā)和使用(利用COTS或定制半導體)。
3. 降低組裝成本:將多個器件集成到一個封裝里,可在系統(tǒng)整體制造流程中顯著降低成本。
4. 降低供應鏈成本:簡化供應鏈。來自不同制造商的多個器件可被單個SiP取代,這樣只需管理較少的供應商和器件,可大大簡化供應鏈。
5. 驗證:子系統(tǒng)和系統(tǒng)級的測試和認證。
Te2v的高級SiP設計和組裝服務成為所有細分市場和產(chǎn)品類型的“一站式商店”(參見圖14)。簡單來說,Te2v不但為宇航級的應用提供設計、組裝和認證服務,也面向其他所有的細分市場、應用和質量等級。
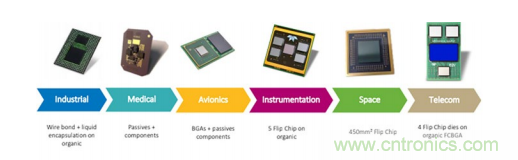
圖 14
最后,隨著高級系統(tǒng)的發(fā)展進入下一個十年,SiP技術已成為減少門長度、減小半導體尺寸的關鍵要素。隨著越來越大的SoC逐漸成為SiP包含的眾多器件之一,使用有機基材和封裝材料進行可靠組裝(焊線或倒裝芯片)的技術需要大量的技術投資。當前,Te2v正準備在未來幾年內(nèi)實現(xiàn)這類技術的進步,所有的技術研發(fā)都由ESA贊助。

結語
當前,數(shù)據(jù)轉換系統(tǒng)的設計師正在經(jīng)歷半導體工藝選擇(和幾何尺寸)、電路小型化需求以及不斷增加的開發(fā)成本等關鍵設計參數(shù)的挑戰(zhàn)。此外,高級系統(tǒng)的開發(fā)可以使用越來越先進的ADC、DAC、微處理器和存儲器件。在工業(yè)、醫(yī)療、航空電子、儀器儀表、通信、軍事和宇航應用領域,一個系統(tǒng)設計的問題一直存在,即如何在模擬電路和數(shù)字電路之間取得平衡,以實現(xiàn)最大的軟件/系統(tǒng)靈活性(從傳感器到計算機輸入/輸出)。現(xiàn)在,高級SiP(系統(tǒng)級封裝)技術的發(fā)展在所有的細分市場和應用中推動了數(shù)據(jù)轉換系統(tǒng)的設計從硬件中心到軟件中心的變革。Teledyne e2v的SiP設計、開發(fā)和組裝的專業(yè)技術革新了系統(tǒng)級設計,實現(xiàn)了最大的靈活性和多任務的能力。Teledyne e2v擁有超過40年的RF、混合信號和數(shù)字處理應用的封裝設計經(jīng)驗,其最先進的SiP設計和組裝技術(焊線、倒裝芯片、有機封裝等)將幫助系統(tǒng)設計師實現(xiàn)高頻直接RF數(shù)據(jù)轉換系統(tǒng)平臺的最高性能和最大價值。
(來源:Teledyne e2v)
免責聲明:本文為轉載文章,轉載此文目的在于傳遞更多信息,版權歸原作者所有。本文所用視頻、圖片、文字如涉及作品版權問題,請電話或者郵箱聯(lián)系小編進行侵刪。








